电子产品小型化趋势 – 需要更复杂的技术来适配更小的尺寸 – 同时影响产品本身和其中的电路板。这种需求推动了对更先进的印刷电路板和微通孔的使用需求。
什么是微孔?
根据IPC-T-50M的最新定义,微孔是直径<=0.15mm的盲埋孔结构,最大纵横比为1:1,起止层的最大深度不超过0.25mm。

IPC-6012还定义了微孔的结构:
- 微导通孔是一种盲孔结构,最大纵横比为1:1,整体贯穿深度不超过0.25mm。
- 通常,NCAB建议,激光盲孔起止层间的介质厚度为60-80um。
- 微导通孔的直径范围为80-100微米,典型的纵横比区间从0.6:1到1:1,理想水平为0.8:1。
为什么微孔很重要?
电子产品正在复杂化,设计密度的增加意味着,电子产品实现更多功能的同时,我们正面临着电子产品和电路板小型化的挑战。
更小的电子元器件、更小的功能组件,再加上不断缩小的空间,我们需要在更高密度的电路板上实现更精细的线宽间距以及更多的互连。
结果就是,我们需要越来越多直径越来越小的孔,产品的设计密度让传统的电镀通孔无容身之地。这些需求推动了微孔的应用 – 通过激光钻孔这种较小的机械钻孔来连接选定的层(例如1-2层),而非连通所有的层。

HDI结构
IPC-2226定义了HDI的结构,典型的有以下三种类型:
Type 1
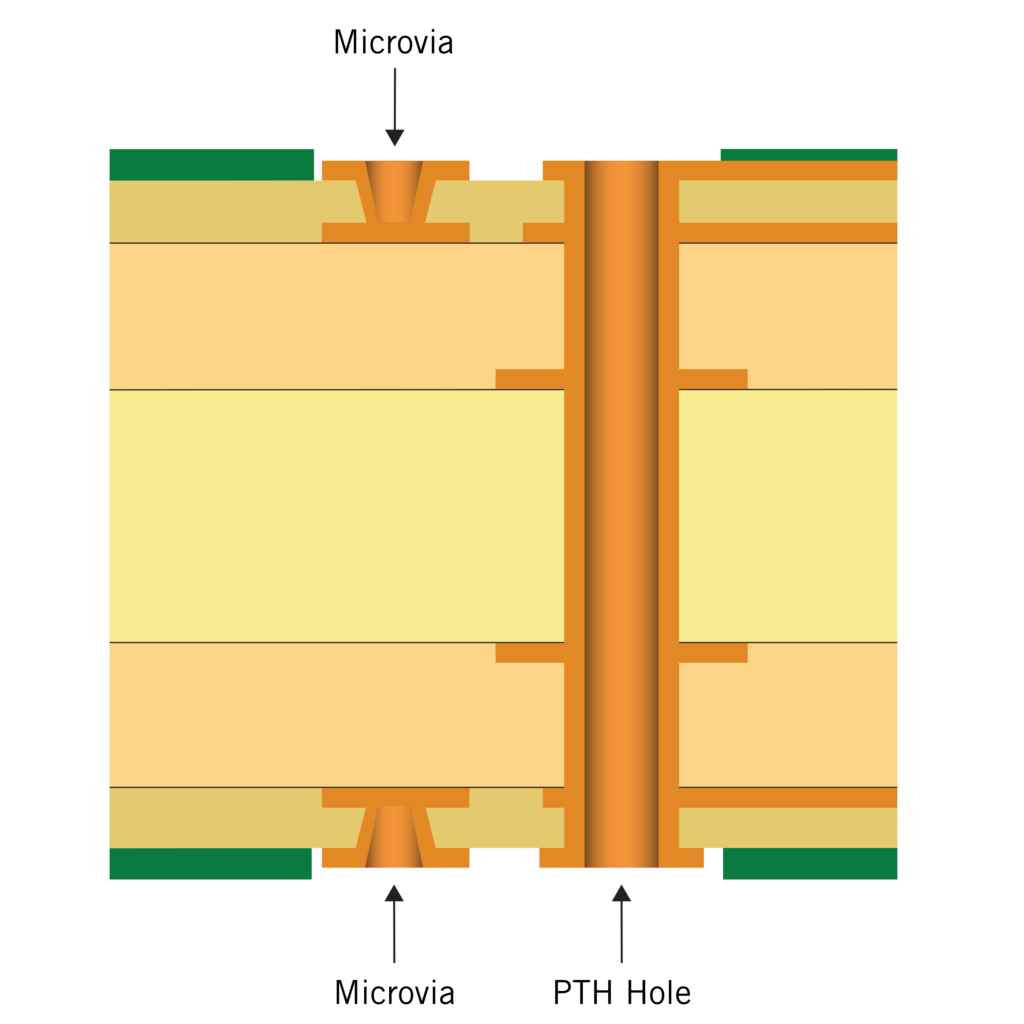
是指外层一层或两侧为单层微导通孔,并结合通孔,实现层间互连。微导通孔的纵横比建议保持在0.8:1,此类型不包含埋孔。
Type 2
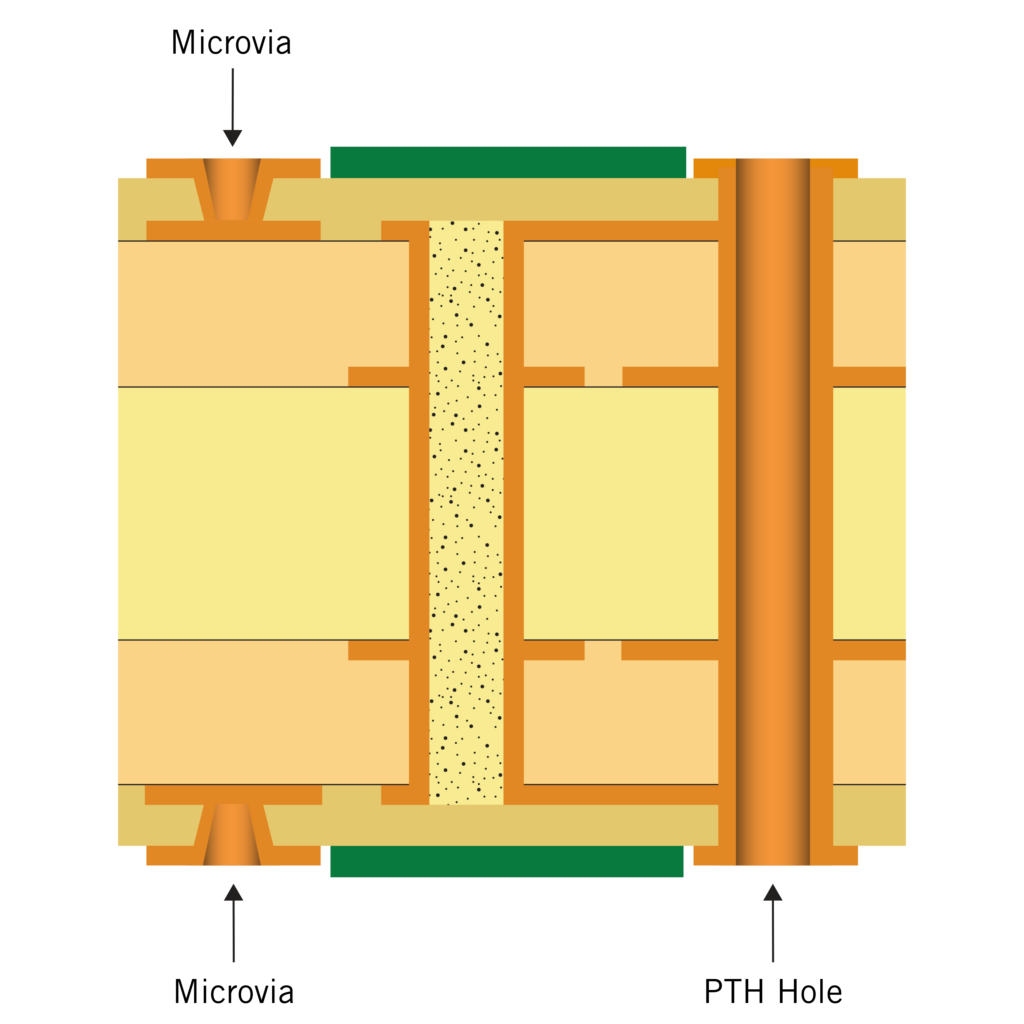
是指外层一侧或两侧为单层微导通孔,采用微孔和通孔实现层间互连,此类型可包含埋孔。
Type 3
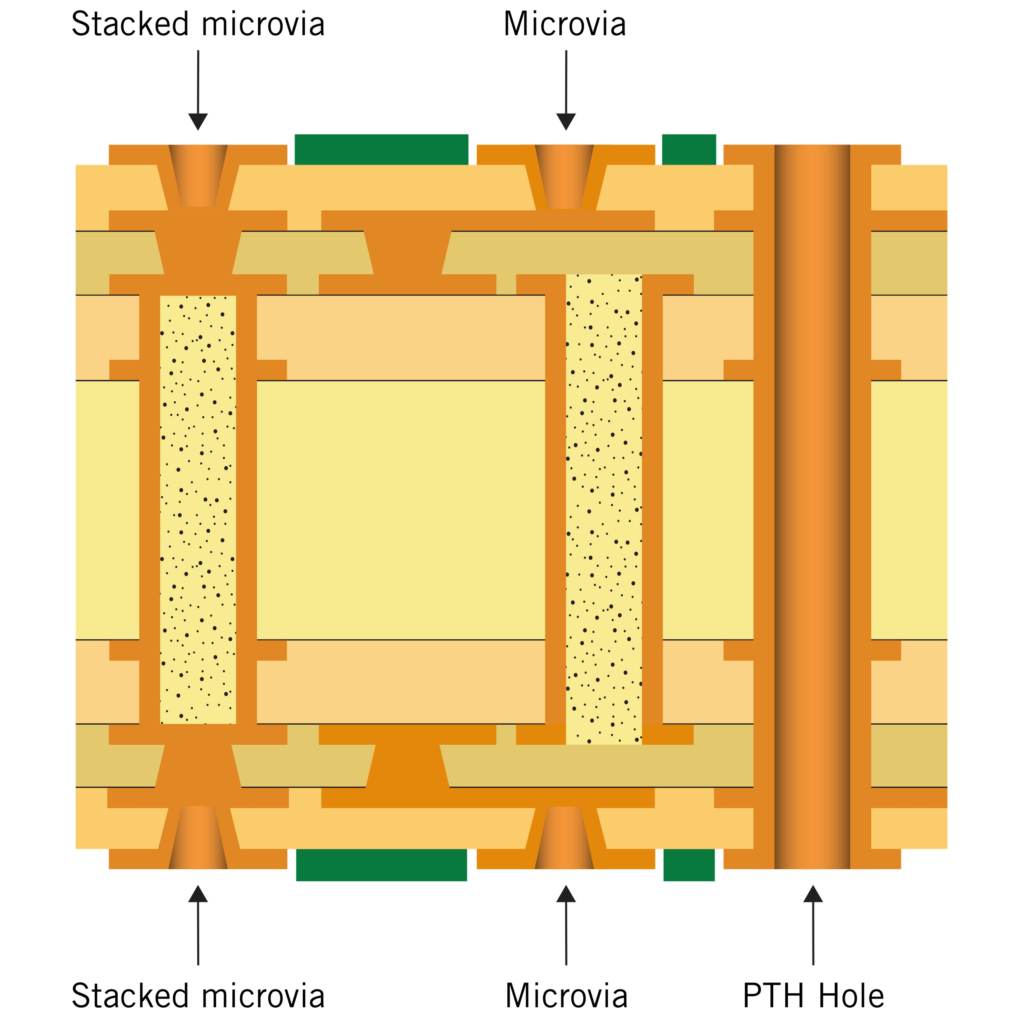
是指外层一侧或两侧有至少两层微导通孔,采用微导通孔和通孔实现层间互连,此类型可包含埋孔。
微孔的设计指南
以下为NCAB制作的HDI PCB设计指南中的摘录,显示了I,II和III型结构的一些细节。然而,III型结构中需要格外注意堆叠结构应限制为2层微孔,并尽量避免堆叠在埋孔上。



| 参数(单位 um) | 推荐 | 先进 | |
| A | Microvia size / diameter | 100 | 80 |
| B | Capture land | 325 (class 2) 350 (class 3) | 250* (class 2) 250* (class 3) |
| C | Target land | 300 (class 2) 325 (class 3) | 250* (class 2) 250* (class 3) |
| D | Dielectric L1 – L2 microvia | 60-80 | 60-100 |
| E | Microvia center to PTH edge | 380 | 300 |
| F | Outer layer space | 100 | 76 |
| G | Inner layer space | 100 | 76 |
| H | Microvia to buried hole | 375 | 300 |
| I | Buried hole to PTH | 450 | 430 |
| J | Pitch – internal microvia (different net) | 425 | 325* |
| K | Pitch – outer microvia (different net) | 525 (soldermask web) 425 (no soldermask) | 325* |
| L | Pitch – staggered microvia | 400 | 225 |
| M | Dielectric for internal microvia | 60-80 | 60-100 |
| N | Buried hole to buried hole | 450 | 350* |
| O | Buried hole size / diameter | 250 | 150 |
| P | Microvia to microvia | 300 | 220 |
| Buried via target land | Buried via + 250 | Buried via + 250* | |
| Q | Skip via microvia size / diameter | 300 | 200 |
| R | Skip via capture land | 500 (via + 200) | 400 (via + 200) |
| S | Skip via target land | 600 (via + 300) | 500 (via + 300) |
| T | Dielectric L1-L3 skip via | 200 | 160 |
| U | Skip via to copper on L2 | 250 | 150 |
* 对于更复杂的设计,请咨询您当地的NCAB技术人员,以给予最佳的建议。
堆叠或交错的微孔结构?
对于堆叠式和交错式的微孔设计,IPC已经组织了一个测试部门来研究用于高端产品的堆叠式微孔设计的可靠性。
近年来有也关于该类设计造成的故障报告,似乎是微通孔与另一通孔或通孔连接导致的。这种问题常见于复杂的堆叠式微孔设计中,而非交错式微孔设计中。
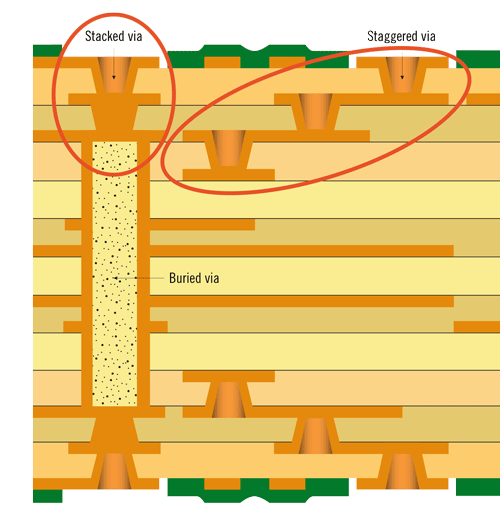
根据目前收集到的数据,3层以上的堆叠式微孔更容易出现问题,虽然故障率整体来看很低,但还是显著高于交错通孔中的类似问题的故障率。
目前的建议是堆叠结构应该限制在两层,并尽量避免堆叠在埋孔结构上。如果需要实现第三层微孔,则第三层微孔应远离两层堆叠微孔结构,以交错式设计实现。
