以下所列的是一些最常见的问题以及经常讨论的话题。希望这里列出的信息对您有所帮助,起到参考作用,或引发更深入的讨论。
HDI
什么是微孔?
根据IPC-T-50M的最新定义,微孔是直径<=0.15mm的盲埋孔结构,最大纵横比为1:1,起止层的最大深度不超过0.25 mm。

什么是盲孔?
盲孔是由外层至内层,但未钻穿整个PCB的导通孔。这类孔可以通过激光或机械方式加工。
问题1中图片所示为激光加工的盲孔。

什么是埋孔?
埋孔是穿透一个内层或多个内层的孔,通常采用机械方式钻孔。
什么是HDI PCB?
根据IPC-2226定义,HDI是指单位面积布线密度高于常规印刷电路板。与常规PCB技术相比,这些电路板采用更细的导线和间隙(≤ 100 µm/0.10 mm)、更小的导通孔(<150 µm)和焊盘(<400 µm/0.40 mm),以及更高的焊盘密度(>20 焊盘/cm2)。
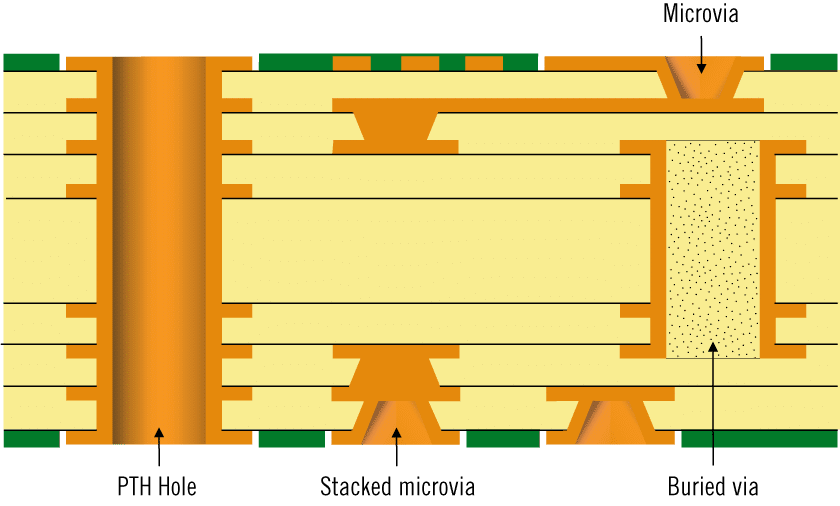
HDI 有哪些不同类型?
下图为一些主要的结构 —– IPC-2226定义的I型、II型和III型
I型是指一侧或两侧为单一的微孔。
采用微孔和通孔,而不是埋孔,实现层间互连。
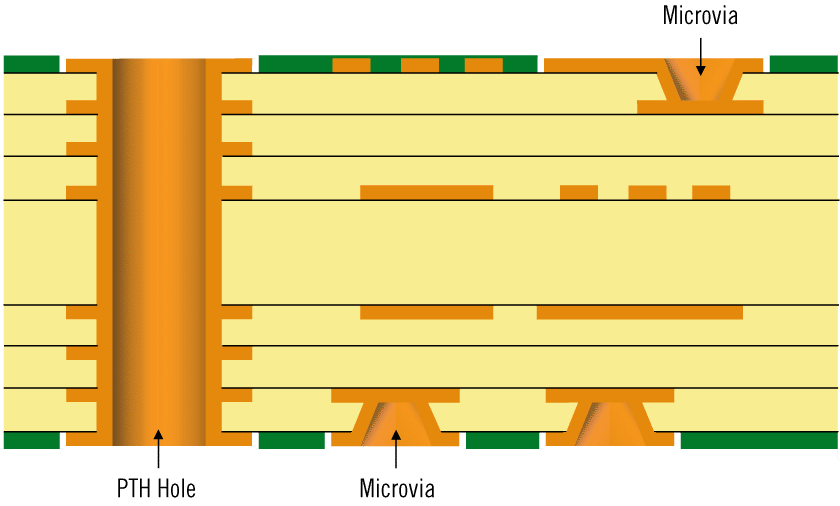
II型是指一侧或两侧为单一微孔。采用微孔和通孔实现层间互连,可包含埋孔。
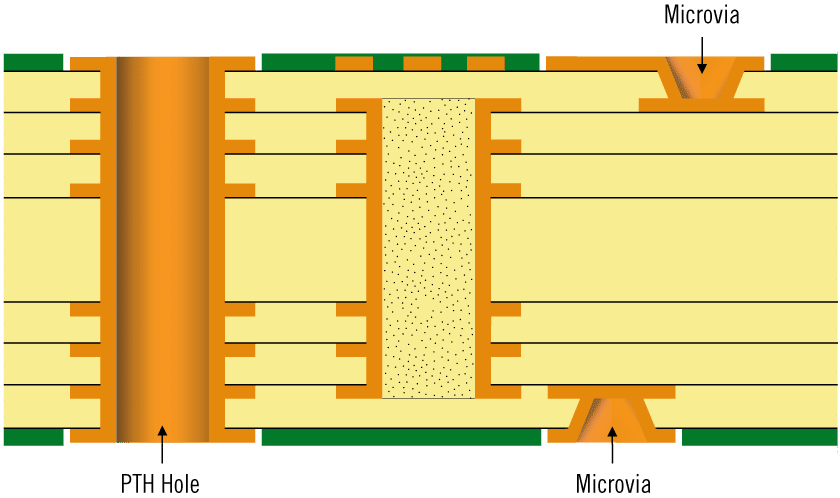
III型是指一侧或两侧有至少两层微孔。采用微孔和通孔实现层间互联,可包含埋孔。
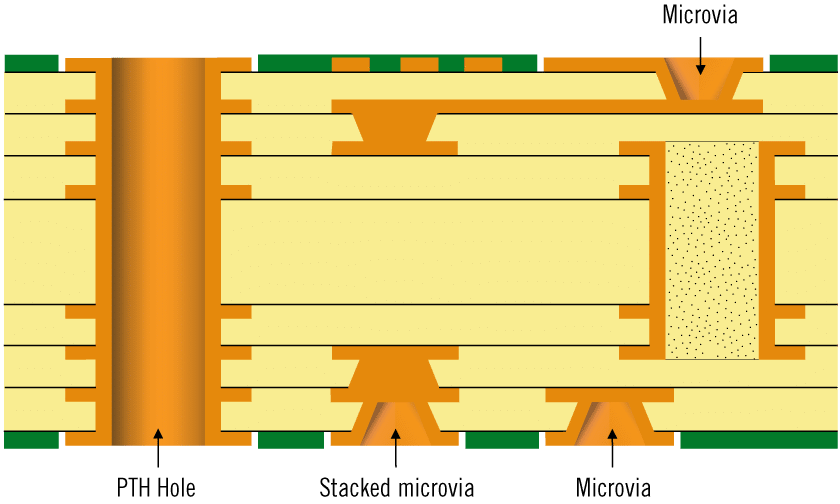
常见的HDI层间结构:
- 1+n+1 = 一层微孔层(如上述I型和II型)
- 2+n+2 = 两层微孔层(如上述III型)
- 3+n+3 = 三层微孔层
FLEX/RIGID-FLEX
刚性和刚柔PCB可采用哪些结构?
可采用多种不同结构,较常见结构如下:
单面柔性(IPC-60103 1型)覆盖膜(聚亚酰胺 + 粘接剂)黏合到无粘接剂的单面FPC芯板,使用或不使用补强。

双面柔性(IPC-6013 2型)覆盖膜黏合到无粘接剂,有镀通孔的双面FPC芯板的两面(两个导电层),使用或不使用补强。

多层柔性(IPC-6013 3型)覆盖膜黏合到无粘接剂构造的两面,包含三个或多个有镀通孔的导电层,使用或不使用补强。能力为 4L。

传统刚柔构造(IPC-6013 4型)多层刚柔电路组合,包含有镀通孔的三层或多层软板。能力为 22L,带10L 柔性层。

不对称刚柔构造,其中FPC位于刚性构造的外层,包含有镀通孔的三层或多层。

多层刚柔构造,埋孔/盲孔(微孔)作为刚性构造的一部分,可实现 2 层微孔。可能还包含两个刚性结构作为同质结构的一部分。能力为 2+n+2 HDI 结构。
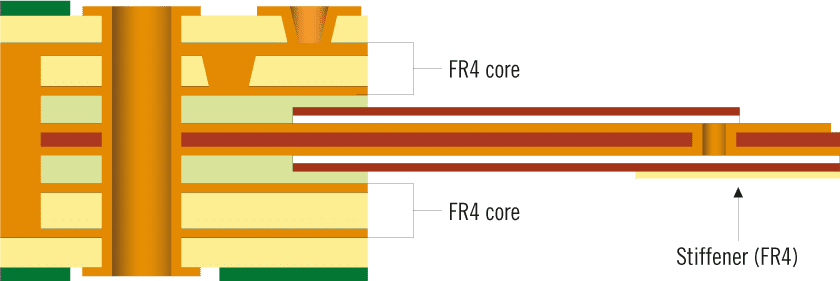
其他复杂的结构
柔性板的层面之间有空隙,以改善FPC的弯折性能。或构造上的柔性层可能有不同长度,以尽量减少弯曲半径内的内部柔性层的压缩度。

如何计算刚柔结构中柔性部分的正确长度,以实现最小弯曲半径?
详细的技术建议请参见IPC-2223的第5.2.3.3条,包括静态和动态弯折,此计算数据应当用于最终设计的验证。关于软板区厚度的某些设计指引如下:

| FLEX TYPE | MINIMUM BEND RADIUS |
|---|---|
| Single sided flex | 3 – 6 x circuit thickness |
| Double sided flex | 7 – 10 x circuit thickness |
| Multilayer flex | 10 – 15 x circuit thickness |
| Dynamic application | 20 – 40 x circuit thickness |
半柔和刚柔板的区别是什么?
半软板其实是使用特定类型FR4制造的“标准”多层PCB,FR4的厚度有特定容差,以便所产生的较薄区域提供传统刚性FR4的柔性/弯曲部分。半软板适合静态应用(软板部分用于组装)或用于弯曲很少的情况。
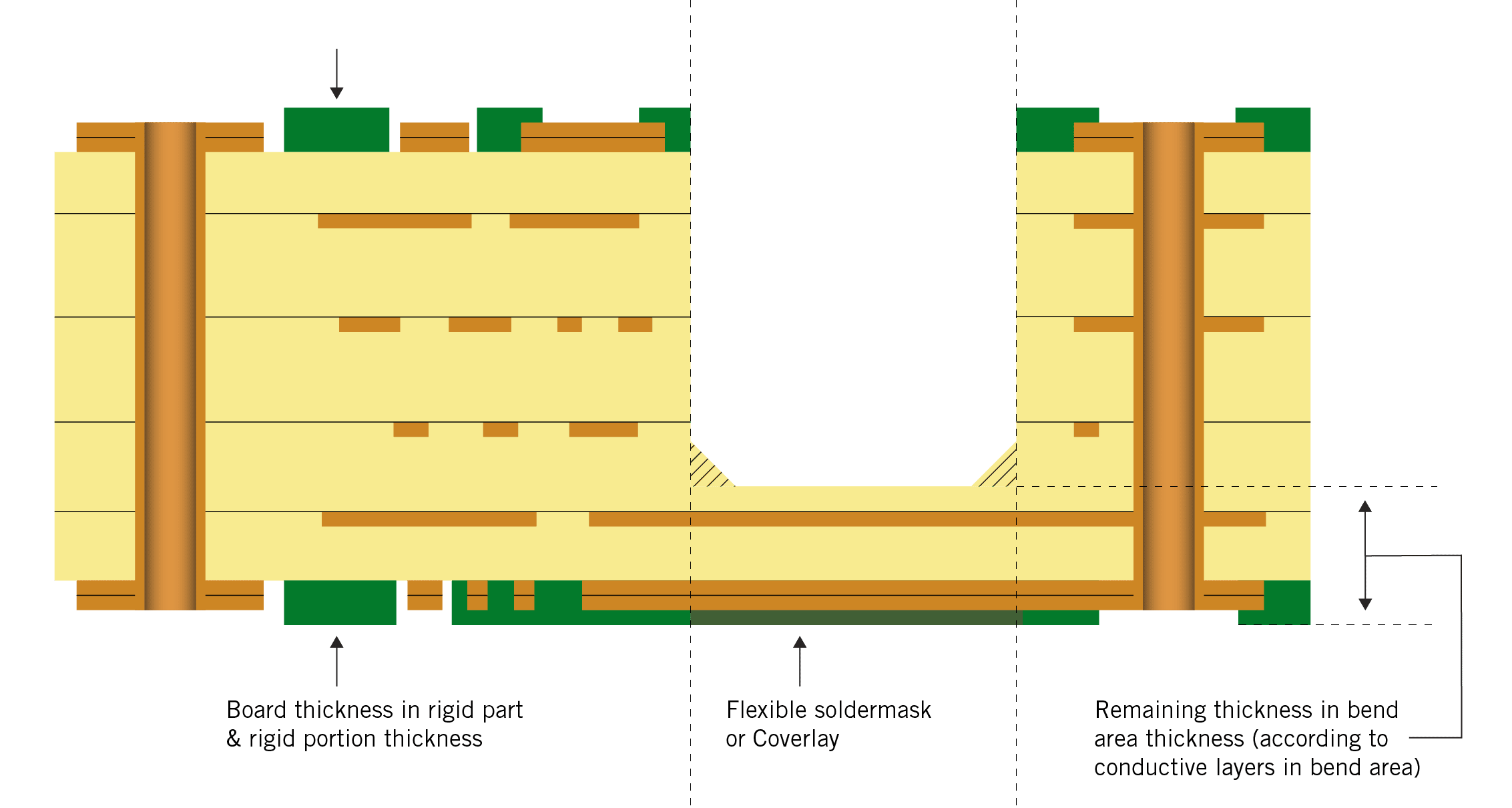
有胶和无胶柔性系统的区别是什么?
使用有胶体系的结构依靠粘接剂将铜料黏合到柔性芯体,使该粘接层及整层覆盖膜渗入刚性构造,直接进入孔洞。粘接剂的膨胀系数增加时,镀通孔发生问题的风险就会上升,比如因膨胀产生裂缝或孔洞失效,而将该材料放入孔洞本身则可能造成孔壁形成铜料的问题,这是由于粘接剂除渣不佳所致。

改善导通孔 / 镀通孔可靠性的解决方案是采用无胶体系的覆铜系统(铜料直接黏合到聚酰亚胺),限制覆盖膜重叠到电路板的刚性部分。此举可防止粘接剂渗入孔洞,确保大幅提高镀通孔结构的可靠度。到目前为止,这是刚柔板最常见的处理方式。
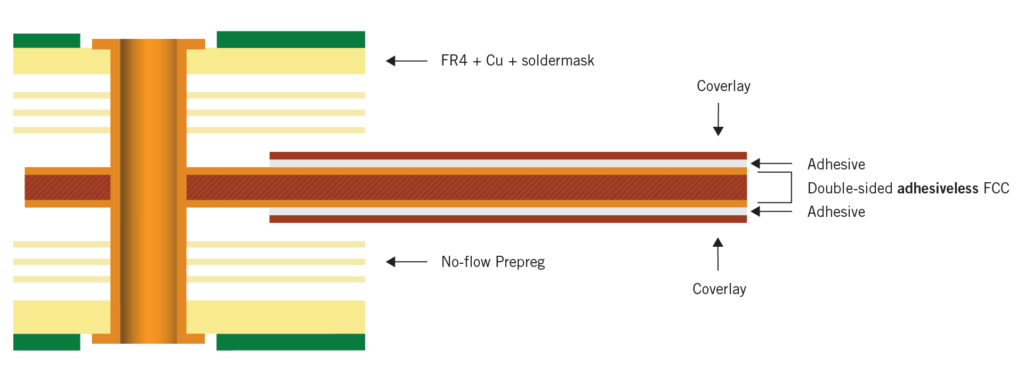
DESIGN RULES
内外层电镀孔的最小焊环是多少?
这会因制造商而异,但通常来说大多数制造商都能生产以下规格:
A = 0.15 mm
B = 0.20 mm
C = 0.30 mm
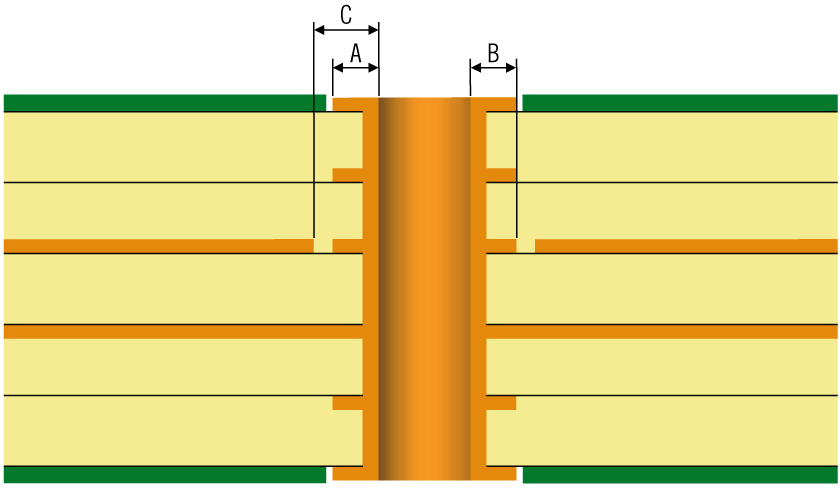
当我需要的线路比标准线路厚时,可以选用哪种线路宽度?

通常,基板底铜越厚,线路应该越宽。根据经验,一块18 µm厚度的铜基板,线路宽度不应小于0.1 mm (4 mil);105 µm厚的铜基板,线路宽度不应小于0.25 mm (10 mil)。
成品铜厚的管控依据?
人们通常有一种误解,以为一定重量铜的厚度是固定不变的,并且在PCB制造期间不会改变。例如一盎司 = 35 µm或半盎司 = 18 µm。
根据IPC-6012,成品板的铜箔允许最小厚度是基于铜箔的来料允许误差和随后加工过程中的电镀铜的损失。
以下所示为标准的铜箔厚度,和可接受的成品铜最小厚度。
理解您自身的需求和正确定义规范是至关重要的,否则可能会要求偏低或过高,从而增加产品成本。详情请咨询我们的技术人员。
| 加工后的内层铜箔厚度 | |
| 基铜重量 | 加工后的最小成品铜厚 |
| 1/2 盎司 | 11.4 um |
| 1 盎司 | 24.9 um |
| 2 盎司 | 55.7um |
| 电镀和加工后的外层导体厚度 | ||
| 基铜重量 | 按2级标准管控的最小成品铜厚 | 按3级标准管控的最小成品铜厚 |
| 1/2 盎司 | 33.4um | 38.4um |
| 1 盎司 | 47.9um | 52.9um |
| 2 盎司 | 78.7um | 83.7um |
我们应当移除还是保留无功能焊盘?
IPC-2222A第9.1.4点明确规定,制造商不得移除这些焊盘,但许多工厂要求允许移除这些焊盘,以实现更高产出量。如果这些焊盘对功能无关紧要,我们建议考虑将其移除。

TERMINOLOGY
什么是“纵横比”?
这是成品板厚与最小过孔直径之间的比值。当一家工厂声称他们的纵横比制程能力是8:1时,这意味着,比如,最小过孔直径是0.2mm, 而对应的成品板厚则是1.6mm.
对于HDI结构,微孔的最佳纵横比通常为 0.8:1,为便于电镀最好采用1:1。

什么是包覆铜?
包覆铜是指从孔壁接近孔口位置到表面连续镀铜(如果是HDI结构,则包含从孔口延伸至内层表面) ,至少25 µm长度。
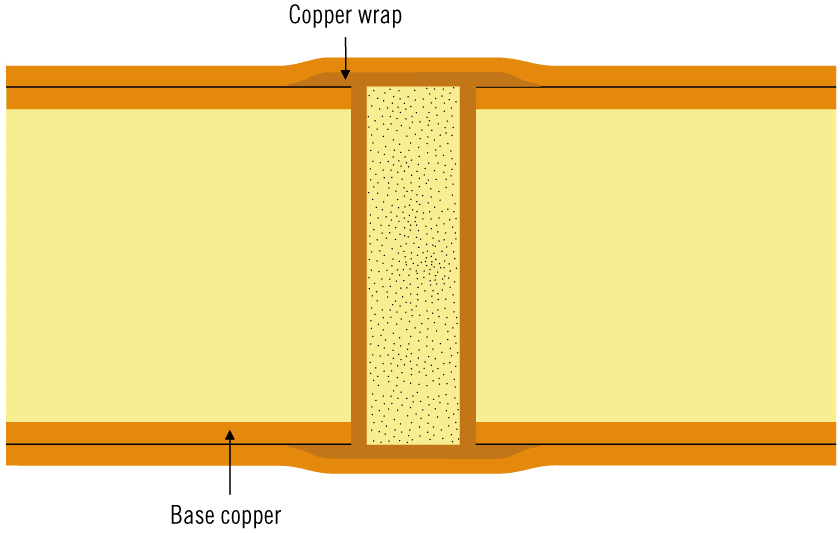
按照IPC 2级标准,包覆铜的厚度至少5 µm,而3级标准则取决于包覆铜过孔在构造中的具体位置。欲详细了解3级标准的要求,请咨询我们的技术人员。
什么是埋铜PCB?
埋铜PCB是在多层电路板内嵌入铜块,实现从一侧到另一侧或从特定层到外层的直接散热。
什么是阻抗控制?
想象一下PCB 信号沿导体前进的情景,控制阻抗是指控制该信号在导体某一点上的表现或速度,与相关导体的电阻、电容和导电性有关。阻抗的测量单位也是Ohms,但不同于电阻,后者是直流电的特征值,而阻抗是交流电的特征值,也就是跟频率有关。
是否存在一种以上的阻抗控制?
是的,请看下面的解释
差分阻抗 – 带有相等和相反极性信号(彼此反相振幅相同)的一对导体的阻抗。
奇模阻抗 – 同时具有相等和相反极性信号(反相振幅相同)的一对导体的单面阻抗。
偶模阻抗 – 具有相等信号 (振幅和极性相同)的一对导体的单面阻抗。
共模阻抗 – 具有相等信号(振幅和极性相同)的一对导体的阻抗。
热焊盘是什么意思?
对于SMD部件(尤其是较小部件),会使用热焊盘模拟两个终端具有相同热质,以避免墓碑效应、组件扭曲,甚至最糟糕情况中部件断裂。


对于通孔插装(HMD)部件,我们会在内层平面使用热焊盘以帮助孔壁沾锡。热焊盘的配方参见IPC-2220系列。

是否应当在采购文件中批准添加泪滴?
根据新的IPC-6012D第3.4.2节,当PCB应满足IPC 1&2级标准时,允许在线路中添加泪滴。

如果您不想要泪滴,请在采购文件中强调这一点,但要添加足够的孔环。
什么是背钻技术?
对于高频率应用,我们需要防止信号损失;因此,当各层相连接,信号从一层传到另一层时,信号必须通过连接两层的导通孔。例如,信号是从20层电路板的一层通往另一层,那么一部分导通孔结构会被视为“多余”;对于这项应用,最好是从该孔洞中去除多余铜料,因为它起到天线的作用,会影响信号。
我们使用背钻(在 z轴控制深度),钻出孔洞中的“多余”铜料,以提高信号的稳定性。在理想情况下,留铜长度(“多余”铜料)越短,效果越好。背钻尺寸一般应比对应的导通孔大0.2 mm。
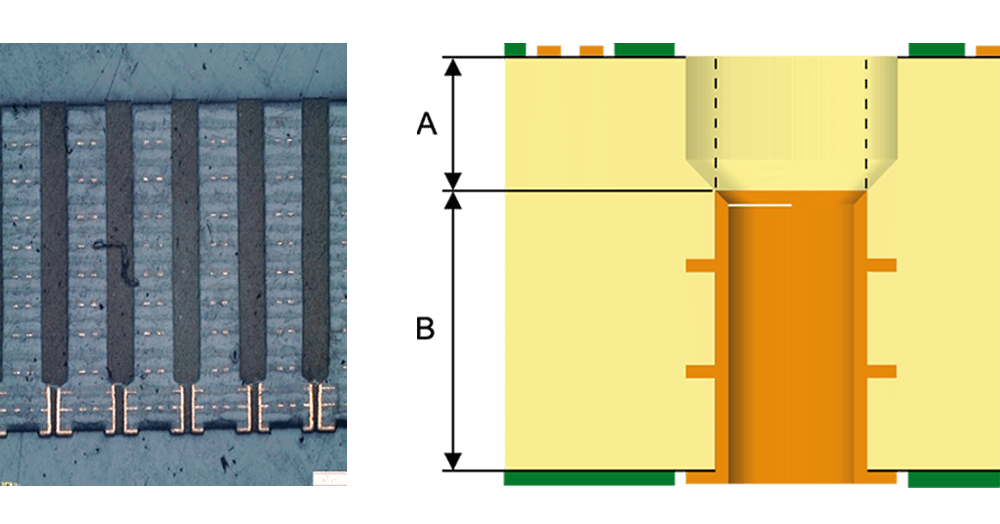
| BACK DRILLING / COUNTER BORE (mm) | |||
|---|---|---|---|
| A: Depth tolerance | +/-0.20 | +/-0.15 | +/-0.10 |
| B: Min. remain thickness and tolerance | 0.5+/-0.25 | 0.35+/-0.1 | 0.3+/-0.1 |
“UL标记”的含义是什么?
安全对电子行业至关重要。成品必须在火灾和电气安全等方面万无一失。这意味着PCB及其中包含的材料必须符合最高标准。为确保电路板合格,通过UL对组成材料或PCB本身进行认证已成为惯常做法。
首先,什么是UL?UL是Underwriters Laboratories的缩写。UL认可为何重要?UL 是一个检测火灾和电气安全的权威机构。世界各地的客户(包括知名的中国企业)都要求工厂获得UL认证。因此,PCB 工厂要生产安全的电路板,并能够进入国际市场,拥有UL认证非常重要。
VIA HOLE
推荐使用哪种过孔塞孔方式?
多数产品(不包括电镀封孔)的首选塞孔方式是”IPC 4761 Type VI” —– 塞孔和覆盖,目标塞孔深度是完全填充,而NCAB通用规范界定为塞孔深度≥70%则可接受。下图为按照IPC4761 VI采用阻焊塞孔的图示。

不建议使用单面塞孔(包括IPC4761 II型的阻焊覆盖),因为孔内可能残留化学药水,或喷锡时锡珠入孔(包括有铅喷锡和无铅喷锡)。
什么是电镀封孔?
电镀封孔是指对过孔做填平处理并使其表面完全金属化,表面铜镀层厚度需要至少达到IPC 2级标准的5 µm,或3级标准的12 µm。

因此填充材料必须是环氧树脂,而不能是阻焊,因为环氧树脂可最大限度降低产生气泡或焊接过程中填料膨胀的风险。这就是IPC-4761 VII型 – 填充和覆盖的塞孔方式,通常用于盘中孔或高密度BGA区域。
MATERIAL
无铅焊接是否必须使用高 Tg(Tg = 玻璃转化温度)的 FR4 材料?
不,不一定。需要考虑许多因素,如层数、厚度,和对贴片工艺(如焊接次数,高于260度以上的持续时间等)的深刻理解。研究表明,“标准”Tg值材料的性能甚至优于某些高Tg值材料。请注意,即使采用“有铅”焊接,其温度也会超过Tg值。
最重要的是材料在温度高于Tg值(Tg之后)时的性能,因此了解电路板将要承受的温度曲线有助于评估必要的性能指标。
选材时需要考虑哪些材料特性?
以下是要首先考虑的特性:
CTE
衡量加温后材料的膨胀性能指标。Z轴性能 – 通常在Tg温度之上其膨胀更大。如果CTE性能不足,那么组装期间在高于Tg温度时材料膨胀会导致失效。即使Tg相同,材料的 CTE 也可能不同,CTE 越低越好。同样,某些材料的Tg值较高,但在Tg温度之上时其 CTE也仍然较高
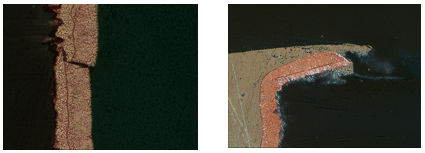
Tg/玻璃转化温度
Tg值是指材料从较为刚性的玻璃态转化为更具弹性和弯曲度的橡胶态时的温度。请注意,高于Tg时,材料特性将发生改变。
Td/分解温度
这是衡量材料分解的指标,是使材料重量损失达5%时的温度,此时其可靠性会急剧下降并可能出现分层。
可靠性较高的PCB需要 Td ≥ 340℃
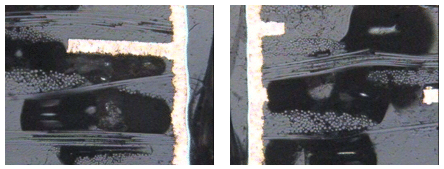
T260/T288/不分层持续时间
这是指在某预定温度下(此处为260℃或288℃)PCB厚度出现不可逆转的改变时的可持续时间,即材料受热膨胀直至分层。
无铅焊接是否必须使用高Td的FR4材料(Td=分解温度)?
Td值越高越好,尤其是技术性复杂并需要多次焊接的电路板,但这会增加成本。了解焊接流程有助于做出正确选择。
作为FR4环氧树脂的固化体系的一部分,“Dicy”和“Non Dicy”有何区别?
对这种环氧树脂而言,Dicy是迄今为止最常见的固化体系;它通常能达到300–310°C的Td值要求,而“Non Dicy”,即酚醛固化的环氧树脂则能达到330–350°C的Td值要求,因此后者能更好地耐高温。
CAF意味着什么?
CAF(玻纤纱式漏电)意味着铜阳极与阴极之间会有电化学反应,从而可导致材料内部短路,最终产品功能失效。
就无铅焊接而言,哪种PCB表面处理最好?
不存在“最佳表面处理”一说;所有的表面处理都有其优点和缺点。选择哪种表面取决于多种因素。请咨询我们相关的技术人员,或查阅本网站本部分中有关表面处理的信息。
有关阻燃剂有哪些规定?有没有针对电子行业中盛行的TBBP-A的国家禁令?
没有,调查表明,由于现实的原因,不可能禁止。
以反应剂或添加剂形式添加的阻燃剂有何不同?
反应型阻燃剂以化学方法与环氧树脂结合,废弃时不会从产品中溶解和释出。
FR4材料能够耐住多少次的回流焊?
很难给出一个准确的答案,但我们曾做过试验表明,回流焊次数最多可以达到22次,其中四次的波峰值温度为270C°。22次回流焊所造成的应力是巨大的,材料性能可能会降低,但所有连通性都依然如故。我们的建议是,PCB层数超过6层、板厚超过1.6 mm时,选择高tg的材料。
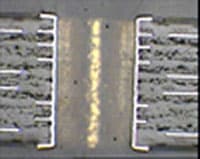
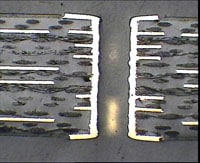
RoHS
RoHS或WEEE指令是否规定PCB必须加标记?
没有,但为便于使用,采用无铅的水平喷锡板应清晰标明,以表明其RoHS兼容性,以免与有铅水平喷锡板混淆。
RoHS兼容PCB是否也不含卤素?
不,不一定。RoHS指令禁止使用两种溴化阻燃剂,即PBB(多溴联苯类)和PBDE(多溴二苯醚类)。PCB中通常使用一种名叫TBBP-A(四溴双酚A)的溴化阻燃剂。
