Tässä on lueteltu joitakin yleisimmin esitetyistä kysymyksistä ja yleisiä keskustelunaiheita.
HDI
Mikä on mikroläpivienti?
IPC-T-50M-standardin uuden määrityksen mukaan mikroläpivienti on sokea läpivienti, jonka suurin sivusuhde on 1:1 ja jonka kokonaissyvyys on korkeintaan 0,25 mm, mitattuna läpiviennin pinnan juotospisteestä pohjassa olevaan juotospisteeseen.

Mikä on sokea läpivienti?
Se on reikä, joka alkaa ulkokerroksesta, mutta se ei yllä koko piirilevyn läpi. Nämä reiät porataan mekaanisesti tai tehdään lasertekniikalla. Kuvassa on lasertekniikalla tehty sokea läpivienti.

Mikä on haudattu läpivienti?
Se on reikä yhden tai useamman sisäkerroksen välillä. Ne porataan yleensä mekaanisesti. Niitä ei voida nähdä piirilevyn pinnalta.
Mikä on HDI-piirilevy?
IPC- 2226:n mukaan HDI on piirilevy, jossa johtimia on tiheämmin yksikköpinta-alalla kuin tavallisissa piirilevyissä (PCB). Niissä on kapeammat sekä ohuemmat johtimet ja myöskin välit ≤ 100 µm / 0,10 mm, pienemmät läpiviennit (<150 µm) ja sisäkerroksessa laservia’n kohdekontakti 20 juotospistettä/cm2) kuin tavallisessa piirilevytekniikassa.
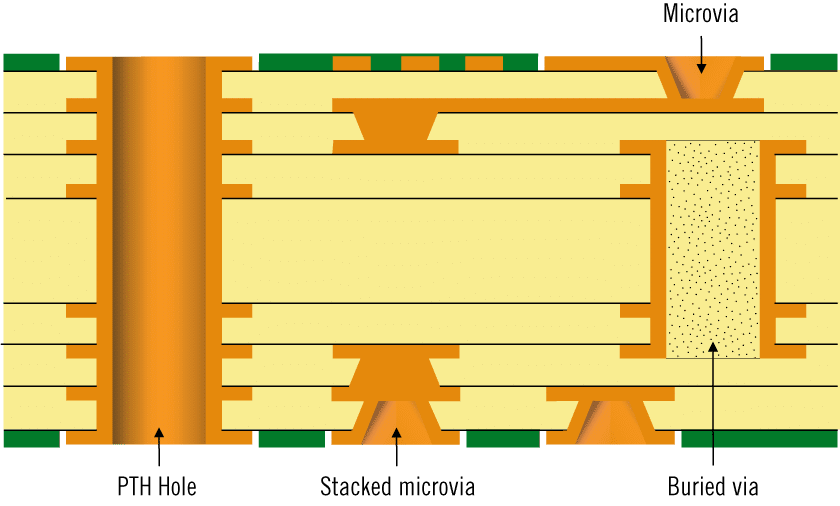
Onko erilaisia HDI-rakenteita saatavilla?
Alla oleva kuva esittää päärakenteet – Tyyppi I, Tyyppi II ja Tyyppi III standardin IPC- 2226 mukaan.
Tyyppi I. Yksi mikroläpivientikerros ytimen (core) toisella tai molemmilla puolilla. Liitäntöihin käytetään sekä metalloituja mikroläpivientejä että porattuja kuparoituja reikiä. Läpiviennit voivat olla sokeita mutta ei haudattuja.
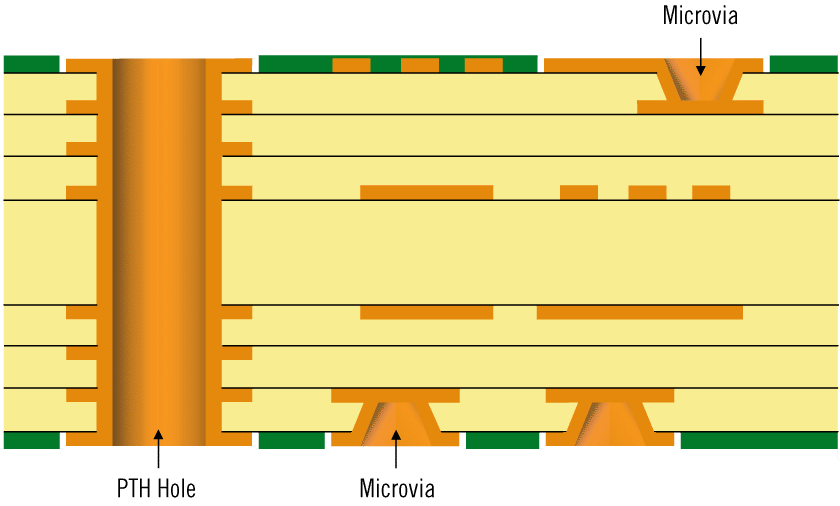
Tyyppi II. Yksi mikroläpivientikerros ytimen (core) toisella tai molemmilla puolilla. Liitäntöihin käytetään sekä metalloituja mikroläpivientejä että porattuja kuparoituja reikiä. Läpiviennit voivat olla sokeita ja haudattuja.
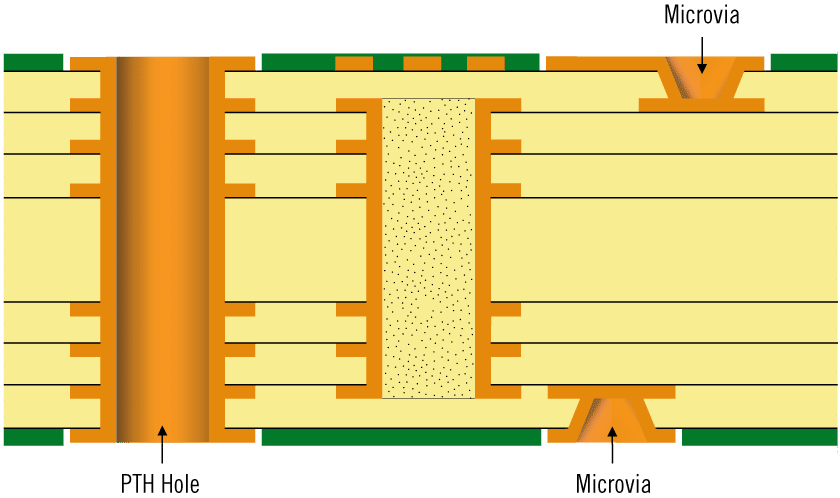
Tyyppi III. Vähintään kaksi mikroläpivientikerrosta ytimen (core) toisella tai molemmilla puolilla. Liitäntöihin käytetään sekä metalloituja mikroläpivientejä että porattuja kuparoituja reikiä. Läpiviennit voivat olla sokeita ja haudattuja.
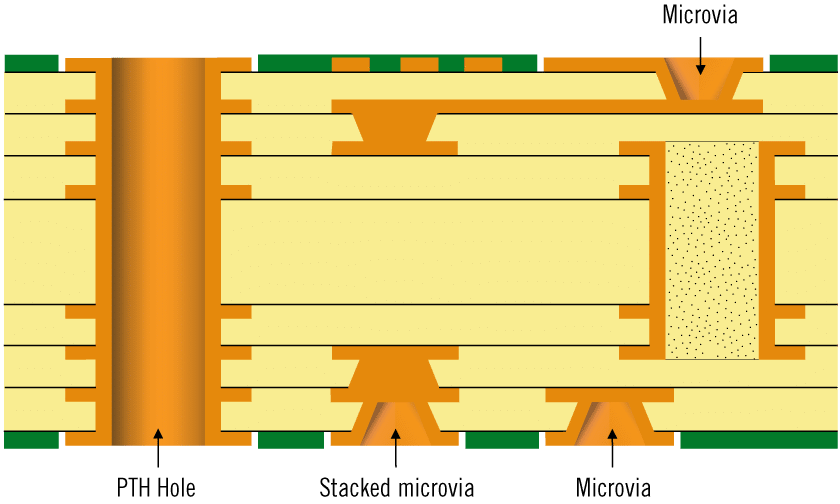
Rakennetta koskeva terminologia, joka määrittää HDI-rakenteen vaativuuden:
- 1+n+1 = yksi mikroläpivientikerros (kuten edellisen esimerkin tyyppi I ja tyyppi II)
- 2+n+2 = 2 mikroläpivientikerrosta (kuten edellisen esimerkin tyyppi III)
- 3+n+3 = 3 mikroläpivientikerrosta
FLEX/RIGID-FLEX
Mitä rakenteita on saatavilla flex- ja rigid-flex-piirilevyjä varten?
Eri rakenteita on olemassa monta. Alla on kuvattu yleisimmät:
Yksipuolinen flex (IPC-60103 tyyppi 1) Coverlay (polyimidi + liima) laminoitu liimattomaanyksipuoliseen FPC-ytimeen (core). Jäykisteiden kanssa tai ilman.

Kaksipuolinen flex (IPC-6013 tyyppi 2) Coverlay laminoitu molemmin puolin liimatonta kaksipuoleista FPC-ydintä (core), jossa on läpikuparoituja reikiä. Jäykisteiden kanssa tai ilman jäykisteitä.

Monikerros-flex (IPC-6013 tyyppi 3) Coverlay laminoitu molemmille puolille liimatonta rakennetta, joka muodostuu kolmesta tai useammasta johtavasta kerroksesta. Läpikuparoidut reiät. Jäykisteen kanssa tai ilman jäykistettä. Kyvykkyys 4-kerrosrakentelle

Perinteinen rigid-flex -rakenne (IPC-6013 tyyppi 4) Monikerroksinen jäykkien- ja joustavien osioiden yhdistelmä, jossa on kolme tai useampia kerroksia, joissa läpikuparoidut reiät. Tekninen valmius on 22 kerrokseen asti, joista 10 voi olla flex-kerroksia.

Epäsymmetrinen rigid-flex -rakenne, jossa FPC sijaitsee ulkokerroksessa. Sisältää kolme tai useampia kerroksia läpikuparoiduilla rei’illä.

Monikerroksinen rigid-flex rakenne, jossa haudattuja/sokeita läpivientejä (mikroläpivientejä) rigid osuudessa. Kaksikerroksiset mikroläpiviennit ovat mahdollisia. Voi sisältää myös kaksi rigid-rakennetta. Tekninen valmius on 2+n+2 HDI-rakenne
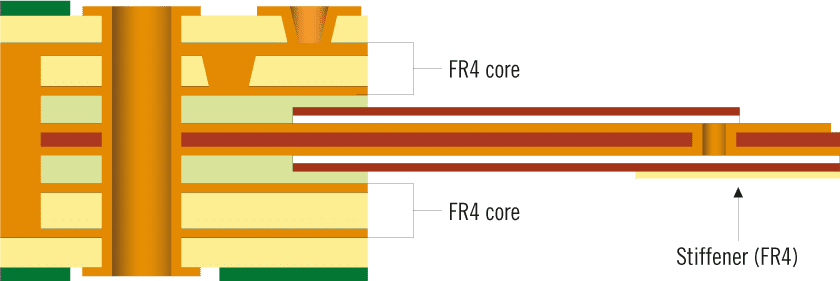
Book-binder- ja air-gap– rakenne – monimutkainen kokoonpano Flex-kerrosten välillä olevat ilmaraot (air-gap) sallivat FPC-levyn paremman taipuvuuden. Joustavat kerrokset voivat olla eripituisia (Book-binder), joka minimoi sisempien joustavien kerrosten puristumista pienemmän taivutussäteen vuoksi.

Kuinka laskea rigid-flex levyn flex osan oikea pituus pienimmän taivutussäteen sallimiseksi?
Yksityiskohtaiset suositukset löytyvät IPC-2223:n kappaleesta 5.2.3.3 sekä staattisille että dynaamisille taivutuksille, ja niitä tulisi käyttää suunnittelun lopulliseen tarkistukseen. Alla voit nähdä joitakin perusohjeita, jotka perustuvat taipuisan materiaalin paksuuteen:

| FLEX TYPE | MINIMUM BEND RADIUS |
|---|---|
| Single sided flex | 3 – 6 x circuit thickness |
| Double sided flex | 7 – 10 x circuit thickness |
| Multilayer flex | 10 – 15 x circuit thickness |
| Dynamic application | 20 – 40 x circuit thickness |
Mitkä ovat semi-flexin ja rigid-flexin eroavaisuudet?
Semi-flex on periaatteessa ”tavallinen” monikerroslevy, joka on paikallisesti ohennettu ja näin aikaansaatu ohuempi alue muodostaa perinteisesti jäykkään FR4-materiaaliin joustavan tai taivutettavan osan. Semi-flex sopii staattisiin sovelluksiin (flex to install) tai sovelluksiin, joissa taivutusten lukumäärä on hyvin rajallinen.
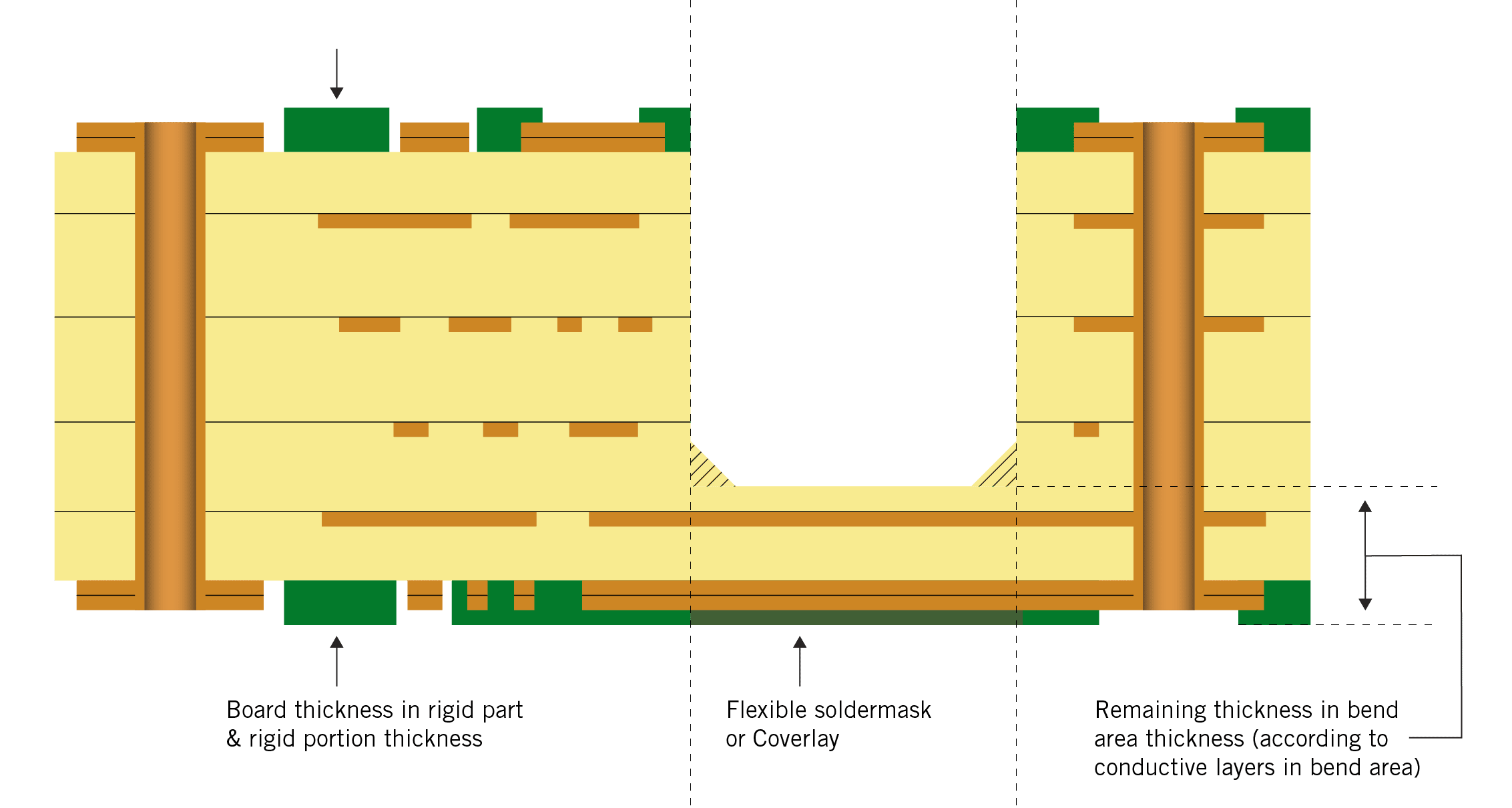
Mikä on adhesiivillisten ja adhesiivittömien flex rakenteiden ero?
Adhesiiviä käyttävissä rakenteissa liima liittää kuparin flex-ytimeen. Tämä liimakerros yhdessä coverlayn kanssa jatkuu rigid- osaan ja läpikuparoituun reikään (PTH). Liiman suurempi laajentumiskerroin lisää riskiä PTH reikien luotettavuusongelmiin, kuten halkeamiin ja läpivientien pettämiseen laajenemisen seurauksena. Jos materiaalia on itse reiässä, se voi johtaa reiän seinämän kuparoinnin ongelmiin.

Ratkaisu läpikuparoitujen reikien luotettavuuden parantamiseen oli siirtyä adhesiivittömään rakenteeseen (kupari liitetty suoraan polyimidiin) ja rajoittaa coverlayn päällekkäisyyttä levyn rigid-osan kanssa. Tämä varmistaa paljon luotettavamman reikien rakenteen ilman liiman tunkeutumista reikään. Tämä on yleisin rigid-flex -menetelmä.
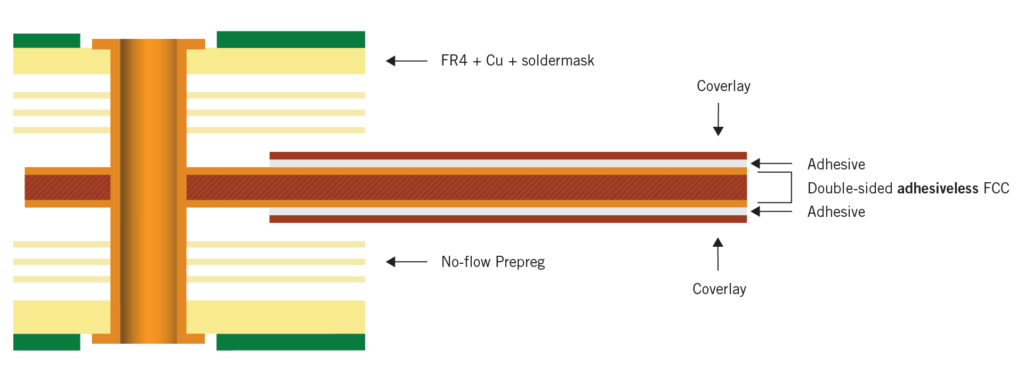
DESIGN RULES
Mikä on pädin reiän vähimmäiskoko ulko-/sisäkerroksessa?
Se vaihtelee eri valmistajien välillä, mutta suurin osa valmistajista voi yleensä tuottaa ne seuraavan kokoisina:
A = 0.15 mm
B = 0.20 mm
C = 0.30 mm
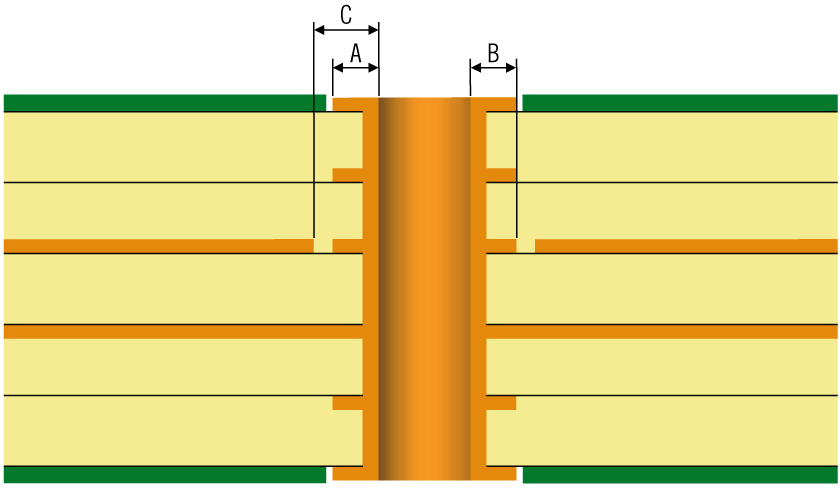
Mitä johdinleveyksiä voin käyttää, jos tarvitsen tavallista paksummat kuparit?

Nyrkkisääntönä on, että mitä paksumpi kupari, sitä leveämpi johdin. Yksi perussääntö on se, että 18 µm:n paksulla kuparilla, johdin ei saisi olla kapeampi kuin 0.1 mm (4 mil) ja 105 µm:n kuparialustalla johdin ei saisi olla kapeampi kuin 0.25 mm (10 mil).
Kuinka paljon kuparin paksuus muuttuu niin sisä- kuin ulkokerroksella näiden valmistusprosessien jälkeen?
On virheellistä olettaa, että lähtökuparin painot varmistavat määritellyt, tarkat paksuudet ja että ne eivät vähenisi piirilevyn valmistuksen aikana. Esimerkiksi 1Oz. = 35um tai ½Oz. = 18 um.
Standardissa IPC-6012 on määritetty kuparifolion ja kuparoinnin jälkeisen folion hyväksyttävät vähimmäispaksuudet, joka perustuvat kuparifolioiden sallittuihin toleransseihin ja kuparipäällysteen kuparimäärän vähenemiseen prosessoinnin aikana.
Alla on esitetty yleisimmät kuparipainot ja sallitut lopulliset paksuudet.
Siksi on erittäin tärkeää ymmärtää, mitä lopullisia kuparipaksuuksia tarvitaan, ja määrittää se oikein niin sisä- kuin ulkokerroksille – jos näin ei tehdä, vaarana on alispesifiointi tai ylispesifiointi, joka voi johtaa rakenteen tarpeettoman suuriin kustannuksiin. Ota yhteyttä teknisiin asiantuntijoihimme, jos haluat lisätietoja.
| Sisäkerrosfolion paksuus prosessoinnin jälkeen | |
| Kuparifolion lähtö/ alkuperäinen paino | Minimipaksuus mikroetsausprosessin/ puhdistuksen jälkeen |
| 1/2 oz. | 11.4 um |
| 1 oz. | 24.9um |
| 2 oz. | 55.7um |
| Ulkoisen johtimen paksuus kuparoinnin ja prosessoinnin jälkeen | ||
| Kuparifolion lähtö/ alkuperäinen paino | Minimipaksuus kuparipinnoitusprosessin jälkeen, Luokka 2 | Minimipaksuus kuparipinnoitusprosessin jälkeen, Luokka 3 |
| 1/2 oz. | 33.4um | 38.4um |
| 1 oz. | 47.9um | 52.9um |
| 2 oz. | 78.7um | 83.7um |
Pitäisikö ei-toiminnalliset pädit poistaa vai jättää?
Standardin IPC-2222A kohdassa 9.1.4 sanotaan selvästi, että valmistajan ei tule poistaa niitä, mutta moni tehdas pyytää lupaa niiden poistamiseen saavuttaakseen tuotannon paremman saannon. Jos ne eivät ole kriittisiä toiminnan kannalta, suosittelemme, että harkitset niiden poistamisen hyväksyntää.

TERMINOLOGY
Mikä on ”aspect ratio”?
Se on reiän halkaisijan suhde reiän pituuteen (= levyn paksuus). Jos valmistaja ilmoittaa ”aspect ratio:ksi” 8:1, niin esimerkiksi 1.60 mm paksussa piirilevyssä reiän halkaisija on 0.20 mm.
HDI-rakenteissa laserilla tehtävän mikroläpiviennin sopiva sivusuhde on yleensä 0,8:1. Kuparoinnin helpottamiseksi 1:1 on suositeltava.

Mikä on kuparinen wrap?
Kuparinen wrap (peitto) on katkeamaton kuparointi, joka alkaa reiän seinämän sisäpuolelta ja jatkuu piirilevyn pinnalle (tai sisäkerroksen pinnalle HDI-rakenteessa) vähintään 25 um:n verran.
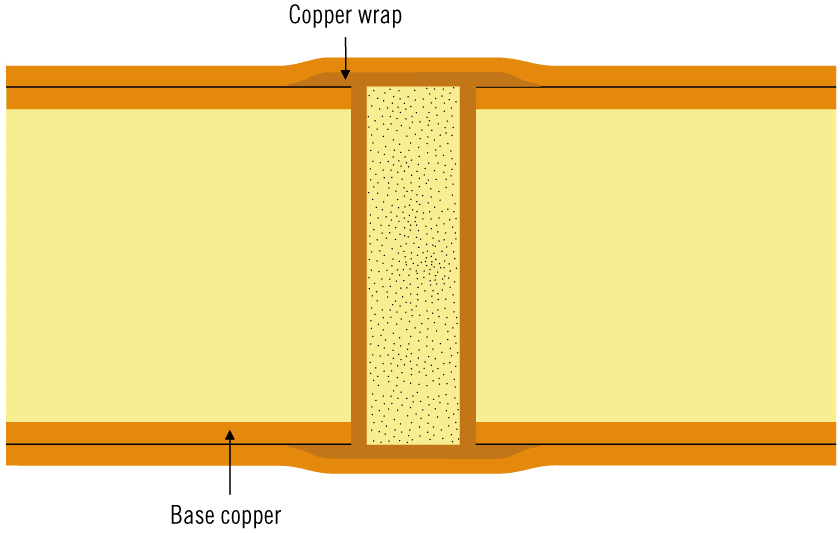
Luokan 2 vaatimustasolla, wrap- kerrostuman vähimmäispaksuus on 5 um, mutta luokassa 3 tämä vaihtelee sen mukaan, missä kohdassa rakennetta kyseinen osa on. Ota yhteyttä teknisiin asiantuntijoihimme, jos haluat lisätietoja luokan 3 vaatimuksista.
Mitä kontrolloitu impedanssi tarkoittaa?
Kun ajatellaan johdinta pitkin kulkevaa signaalia, niin impedanssikontrolli tarkoittaa, että säädämme signaalin ominaisuuksia tai nopeutta jossakin johtimen kohdassa vaikuttamalla kyseisen johtimen resistanssiin, kapasitanssiin ja konduktanssiin. Myös impedanssi mitataan ohmeissa, mutta se on eri asia kuin resistanssi, joka on DC-ominaisuus. Impedanssi on AC-ominaisuus eli se liittyy taajuuteen.
Onko kontrolloituja impedansseja useampaa eri tyyppiä?
Kyllä, ja ne on selitetty alla:
Differentiaalinen impedanssi – Johdinparin impedanssi, kun johdinparilla on samanarvoisen ja vastakkaisen polariteetin signaalit – sama amplitudi vastavaiheessa toistensa kanssa.
Parittoman tilan impedanssi – Johdinparin yhden puolen impedanssi, kun johdinparilla on samanarvoisen ja vastakkaisen polariteetin signaalit – sama amplitudi ja vastakkainen vaihe.
Parillisen tilan impedanssi – Johdinparin yhden puolen impedanssi, kun johdinparilla on samanarvoiset signaalit – sama amplitudi ja sama polariteetti.
Yhteismuotoinen impedanssi – Johdinparin impedanssi, kun johdinparilla on samanarvoiset signaalit – sama amplitudi ja sama polariteetti.
Mitä thermal pad tarkoittaa?
Etenkin pienemmissä SMD-komponenteissa käytetään thermal relief -pädejä, jotka simuloivat molempien liitosten saman suuruista lämpömassaa hautakivi-ilmiön, komponenttien vääntymisen tai pahimmassa tapauksessa komponenttien rikkoutumisen välttämiseksi.


Läpiladottavissa komponenteissa thermal relief -pädejä käytetään sisäkerroksilla auttamaan juotteen nousemista reiän seinämään. Thermal relief -pädien laskukaavat ovat esitetty IPC-2220-sarjassa.

Pitäisikö teardropin lisäämisen hyväksyntä lisätä hankinta-asiakirjoihin?
IPC-6012D kappale 3.4.2 mukaan teardropien lisääminen on sallittu, kun piirilevyjen on oltava luokkien 1 ja 2 mukaisia. Jos et halua teardroppeja, korosta se hankintaohjeissa. Pidä kuitenkin huoli siitä että pädit ovat riittävän suuret.

Jos et halua teardropeja, mainitse se hankinta-asiakirjoissa. Mutta lisää designiin riittävän suuret reiän kaulukset (annular ring).
Mikä on back-drilling –teknologia?
Signaalin häviöitä korkeataajuussovelluksissa on estettävä. Kun johdinkerrokset kytketään toisiinsa ja signaali viedään kerroksesta toiseen, sen täytyy mennä kerroksen yhdistävän läpiviennin kautta. Jos signaalin on tarkoitus kulkea esimerkiksi kerroksesta yksi kerrokseen kaksi 20-kerroksisessa levyssä, voidaan osaa läpivientirakenteesta pitää ”ylimääräisenä”. Siinä tapauksessa ylimääräinen kupari on parasta poistaa kyseisestä reiästä, koska se toimii antennin tapaan ja vaikuttaa signaaliin.
Poraamme back-drilling-teknologialla (kontrolloitu syvyys z-akselilla) ”ylimääräisen” kuparin pois reiästä, mikä parantaa signaalin vakautta. Ihannetapauksessa pätee, että mitä lyhyempi kanta (”ylimääräinen” kupari), sitä parempi tulos. Back-drill poran koko tulee yleensä olla 0,2 mm suurempi kuin vastaava läpivienti.
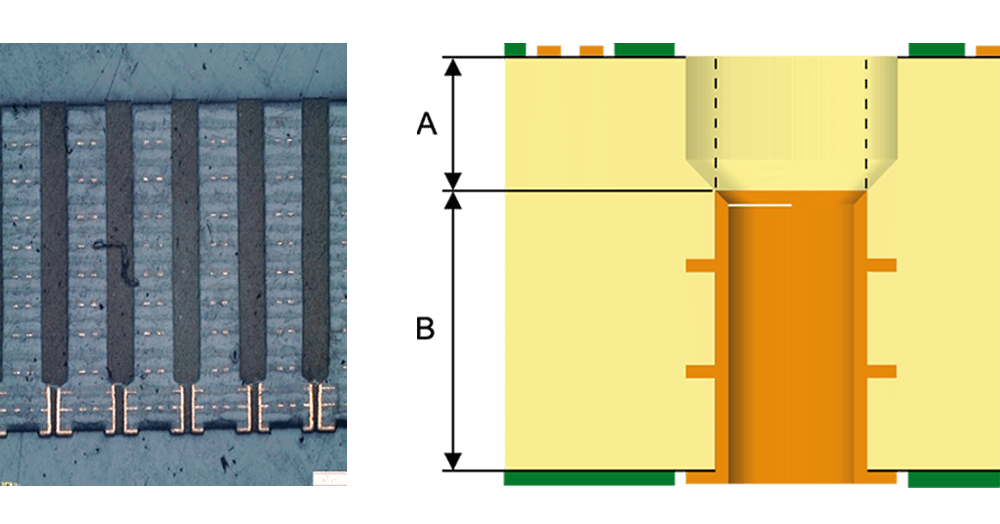
| BACK DRILLING / COUNTER BORE (mm) | |||
|---|---|---|---|
| A: Depth tolerance | +/-0.20 | +/-0.15 | +/-0.10 |
| B: Min. remain thickness and tolerance | 0.5+/-0.25 | 0.35+/-0.1 | 0.3+/-0.1 |
Mitä merkintä ”UL” tarkoittaa?
Turvallisuus on välttämätöntä elektroniikkateollisuudessa. On erittäin tärkeää, että käyttäjät voivat luottaa lopputuotteeseen ja erityisesti sen palo- ja sähköturvallisuuteen. Siksi sekä piirilevyjen että niiden sisältämien materiaalien on täytettävä alan tiukimmat standardit. Piirilevyjen vaatimustenmukaisuuden varmistamiseksi on nykyisin yleistä, että UL sertifioi rakennemateriaalit tai itse piirilevyn.
Aivan aluksi, mikä on UL? Kirjaimet UL tulevat nimestä Underwriters Laboratories. Miksi UL-hyväksyntä on tärkeä? UL on merkittävä organisaatio ja sillä on hyvä maine piirilevyteollisuudessa. Yritys on korvaamaton palo- ja sähköturvallisuuden testaajana. Asiakkaat joka puolella maailmaa – myös tunnetut kiinalaiset yritykset – vaativat tehtaita, jotka voivat saavuttaa UL-hyväksynnän. Siksi UL-hyväksyntä on piirilevytehtaille erittäin tärkeä, jotta ne voivat valmistaa turvallisia levyjä ja päästä kansainvälisille markkinoille.
VIA HOLE
Millaista läpiviennin täyttöä suositellaan?
Vakiotuotteelle (ei sisällä peitettyä läpivientiä) suositeltu täyttötapa on standardin IPC-4761 Tyypin VI mukainen täyttäminen ja päällystäminen, tavoitteena läpivientireiän täyttyminen. NCAB Groupin yleisen spesifikaation mukaan ≥ 70 % on hyväksyttävä! Kuvassa on Tyyppi VI juotteenestopinnoitteella.

Yksipuolista täyttöä (mukaan lukien Tyypin II peitetty ja päällystetty, ei suositella koska syövyttäviä/ kemiallisia aineita saattaa jäädä ”loukkuun” ja ne aiheuttavat kupariseinämän syöpymäriskin! Myöskin juotospallot ovat todennäköisiä käytettäessä HASL-pinnoitteita (LF ja SnPb).
Mikä on peitetty mikroläpivientireikä?
Peitetyssä läpiviennissä, läpivientireiän päälle on lisätty kuparointi, niin että pinta on täysin metalloitu. Kuparoinnin/päällysteen vähimmäispaksuus on 5 um luokan 2 vaatimustasolle tai 12 um luokan 3 vaatimustasolle.

Se edellyttää, että läpiviennin täyttömateriaalina käytetään epoksihartsia eikä juotteenestopinnoitetta, sillä epoksi minimoi ilmakuplien muodostumisriskin ja täyttöaineen laajentumisriskin juottamisen yhteydessä. Se voidaan luokitella IPC 4761 -standardin tyypiksi VII – täytetyt ja peitetyt läpivientireiät. Sitä käytetään yleensä rakenteissa, joissa läpivienti on pädissä, tai BGA-sovelluksissa, jotka vaativat suurempaa osien tiheyttä.
MATERIAL
Onko lyijyttömän juotoksen yhteydessä käytettävä FR4-materiaalia, jonka Tg-arvo on korkea?
Ei välttämättä. Siihen vaikuttavat monet tekijät, kuten kerrosten lukumäärä, piirilevyn paksuus ja kokoonpanoprosessin hyvä tuntemus (juotosjaksojen lukumäärä, aika yli 260 asteessa jne.). Eräät tutkimukset ovat osoittaneet, että materiaalit, joiden Tg-arvo on vakiotasoa, ovat antaneet parempia tuloksia kuin korkeamman Tg-arvon materiaali. Huomaa, että Tg-arvo ylitetään jopa lyijyllisessä juottamisessa.
Tärkeintä on materiaalin käyttäytyminen Tg-arvon ylittävissä lämpötiloissa (post Tg). Kun tunnetaan lämpötila-alueet, joille levy altistuu, tarvittavia suorituskykyominaisuuksia on helpompi arvioida.
Mitkä materiaalin ominaisuudet ovat tärkeitä materiaalin valinnassa?
Seuraavassa on esitetty mielestämme tärkeimmät ominaisuudet:
CTE
Ilmoittaa, kuinka paljon materiaali laajenee kuumennettaessa. Kriittinen Z-akselilla – tyypillisesti Tg-arvon ylittävissä lämpötiloissa laajentuminen on suurempaa. Jos CTE ei ole riittävä, kokoonpanon aikana voi esiintyä vikoja materiaalin laajentuessa nopeasti Tg-arvon ylittävissä lämpötiloissa.
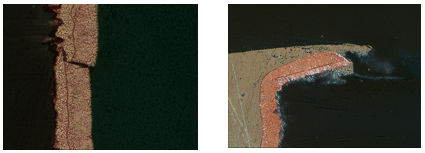
Materiaaleilla voi olla eri CTE samasta Tg-arvosta huolimatta – alhaisempi CTE on parempi. Joillakin materiaaleilla voi olla korkeampi Tg-arvo, mutta myös korkeampi (huonompi) CTE Tg-arvon ylittävissä lämpötiloissa.
Tg / LASITTUMISLÄMPÖTILA
Tg-arvo on lämpötila, jossa materiaali muuttuu kohtuullisen jäykästä lasimaisesta materiaalista elastisemmaksi ja taipuvammaksi muovimaiseksi materiaaliksi. Tärkeä tekijä, koska materiaalin ominaisuudet muuttuvat Tg-arvon ylittävissä lämpötiloissa.
Td / HAJOAMISLÄMPÖTILA
Tämä on materiaalin hajoamisen mittari. Analyysimenetelmä mittaa, milloin 5% materiaalin painosta on hävinnyt – kohta, jossa luotettavuus vaarantuu ja delaminoitumista saattaa esiintyä. Korkean luotettavuuden piirilevylle on vaatimus Td ≥ 340 ℃
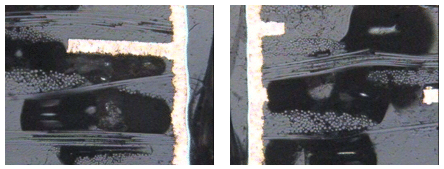
T260 / T288 / AIKA IRTILAMINOITUMISEEN
Tällä menetelmällä määritetään aika, jonka piirilevy kestää esimääritetyssä lämpötilassa (260 tai 288 tässä tapauksessa) ennen kuin se muuttuu peruuttamattomasti eli materiaali laajenee niin paljon, että se irtilaminoituu.
Onko lyijyttömän juotoksen yhteydessä käytettävä FR4-materiaalia, joka Td-arvo on korkea?
Suurempi Td-arvo on suositeltava, etenkin jos levy on teknisesti vaativa ja altistuu useille juotosvaiheille, mutta se voi johtaa korkeampiin kustannuksiin. Kokoonpanoprosessin tuntemus helpottaa oikean ratkaisun valintaa.
Mitä eroa on “Dicy”- ja ”nonDicy”-kovettimilla FR4-epoksin yhteydessä?
Dicy (disyaanidiamiini) on kaikista yleisin kovetin tälle epoksille ja antaa normaalisti noin 300–310 °C:n Td-arvon. Kun taas nonDicy-kovetetun eli fenolikovetetun epoksin Td-arvo on noin 330–350 °C, ja se kestää siksi paremmin korkeita lämpötiloja.
Mitä “CAF” tarkoittaa?
CAF (Conductive Anodic Filament) tarkoittaa, että kuparianodin ja katodin välillä tapahtuu sähkö
Mikä pinnoite on paras lyijyttömään juottamiseen?
Parasta pinnoitetta ei voida nimetä, sillä kaikilla pinnoitteilla on etuja ja haittoja. Paras pinnoite riippuu useista tekijöistä. Ota yhteyttä tekniseen asiantuntijaamme tai lue pinnoitteita käsittelevä kohta verkkosivustollamme.
Mitkä säännöt koskevat palonestoaineita, ja asetettiinko elektroniikkateollisuudessa paljon käytetylle TBBP-A-palonestoaineelle kielto?
Ei, sillä tutkimuksen mukaan sitä ei ollut mahdollista kieltää käytännöllisistä syistä.
Mitä eroa on palonestoaineella, joka on lisätty reaktiivisessa muodossa, ja palonestoaineella, joka on lisätty lisäaineena?
Reaktiivinen palonestoaine on kemiallisesti osa epoksia, eikä se hajoa ja poistu tuotteesta jätteenä.
Kuinka monta reflow-jaksoa FR4-materiaalit kestävät?
Tarkkaa vastausta on vaikea antaa, mutta me olemme tehneet testejä materiaaleilla 22 reflow-jaksoon asti, joista neljässä huippulämpötila oli 270 °C. 22 reflow-jakson jälkeen rasitus on huomattava ja materiaali voi heiketä, mutta kaikki johtimet säilyivät ehjinä.
Suosittelemme valitsemaan korkean Tg-arvon materiaalin, jos kerroksia on enemmän kuin kuusi ja paksuus on yli 1,6 mm.
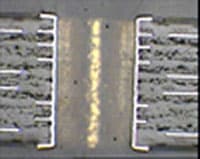
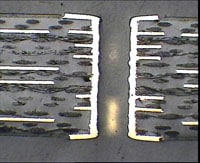
RoHS
Edellyttävätkö RoHS- tai WEEE-direktiivit piirilevyn merkintää?
Eivät, mutta käytännön syistä lyijyttömällä HASL-pinnoitteella varustetut piirilevyt on hyvä merkitä selvästi, mikä osoittaa niiden RoHS-yhteensopivuuden, niin ettei niitä sekoiteta lyijyllisellä HASL-pinnoitteella käsiteltyihin piirilevyihin.
Ovatko RoHS-yhteensopivat piirilevyt myös halogeenittomia?
Eivät välttämättä. RoHS-direktiivi kieltää kahden bromatun palonestoaineen käytön, PBB:n (polybromatut bifenyylit) ja PBDE:n (polybromidifenyylieetteri). Yleensä piirilevyissä käytetään bromattua paloestoainetta TBBP-A (tetrabromibisfenoli A).
