
La necessità, nasce nel momento in cui si pensa non pi ad un oggetto che abbia una unica e semplice funzione, ma ad oggetti accattivanti per prestazioni e aspetto estetico. Che abbiano la possibilità di eseguire molteplici funzioni ed operazioni. L’esempio più classico è il telefono cellulare, da una sola funzione quella di effettuare e ricevere chiamate, ad un vero e proprio sistema di connessione con tutto ciò che ci circonda.
Quindi, stiamo progettando schede elettroniche sempre più piccole, con più funzioni e performance, più sottile e leggere. Tutto questo richiede un processo di progettazione e produzione molto rigoroso per riuscire ad ottenere ottime performance. Per sviluppare quanto abbiamo appena detto, ci servono soluzioni per UNA MAGGIORE DENSITÀ DI CONNESSIONI e chiaramente più strati nel circuito stampato. Il design sempre più stretto, significa meno spazio a disposizione per lo sbroglio, Il che si traduce in piste ed isolamenti più sottili con fori passanti di diametro sempre più piccolo, inoltre sarà necessario utilizzare:
- Fori Laser sui lati esterni
- Fori laser interrati per collegare strati intermedi
- Abbiamo anche bisogno di pre-preg e laminati CCL pi sottili rispetto ai prodotti multistrato convenzionali
Nel momento in cui si sta estremizzando il progetto, è chiaro che tutta la catena deve necessariamente seguire delle linee guida, dal progettista al fornitore di PCB.
La IPC riconosciuta a livello internazionale, ci aiuta molto nel definire queste linee guida curando gli standard di riferimento:
- IPC-2226 riguarda la sezione del design
- IPC-6012 riguarda la sezione di accettabilit delle schede rigide
- IPC-4104 Copre i vari materiali conduttivi e dielettrici che possono essere utilizzati per la fabbricazione di HDI
- IPC-4101 che riguarda le caratteristiche tipiche dei laminati di base
Definizione di HDI PCB
Per la IPC- 6012 è considerato un HDI, quando le connessioni elettriche mediamente arrivano ad un numero di 20 connessioni per cm2, su entrambi i lati del nucleo e generalmente per arrivare a queste condizioni si fa utilizzo di microvias, piste ed isolamenti non superiori ai 100 um. Se pensiamo che i parametri descritti, sono sviluppati su tutti gli strati del circuito, capiamo benissimo che pone grosse sfide tecnologiche per i fornitori di PCB.
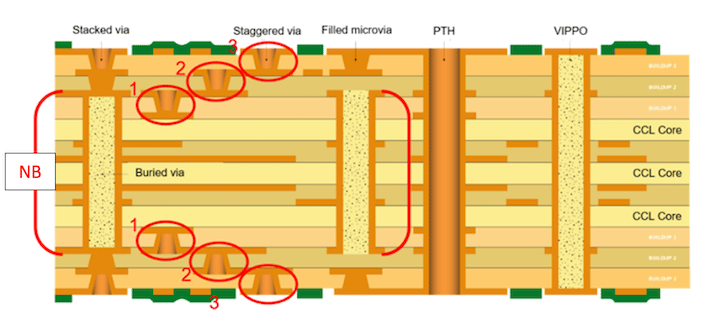
La IPC-6012 definisce anche la struttura di un Microvia.

- Il microvia è una struttura cieca con un aspect ratio massino 1:1 rapporto tra diametro del foro e profondità, Con una profondità totale non superiore a 0,25 mm, se misurata dalla superficie alla pad o piano di destinazione.
Tipicamente NCAB considera lo spessore dielettrico tra superficie e pad di riferimento dai 60 – 80um.
Per le dimensioni diametro dei microvias un range di 80-100 micron. Il RAPPORTO tipico è compreso tra 0,6: 1 ad 1: 1, ideale 0,8:1
La IPC-2226 Definisce per tipologia, la struttura degli HDI, sono tre le possimo osservare nelle immagini messe in evidenza:
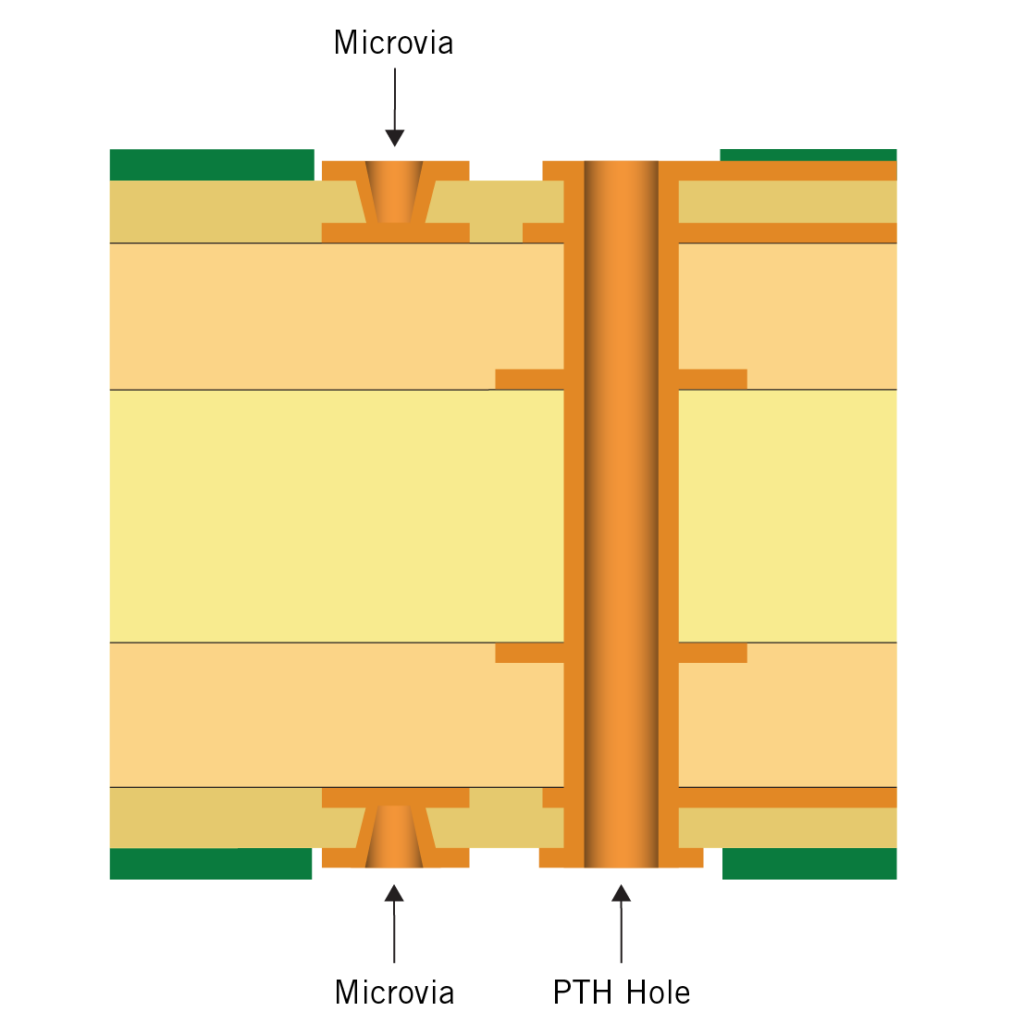
- LE STRUTTURE DI TIPO 1sono quelle che contengono un singolo strato di microvia su uno o entrambi i lati del nucleo. Utilizza per l’interconnessione sia microvia che fori passanti. Importante è contenere il rapporto 0,8 : 1 per i microvia, Questa struttura utilizza SOLO fori ciechi NESSUN passaggio a fori interrati.
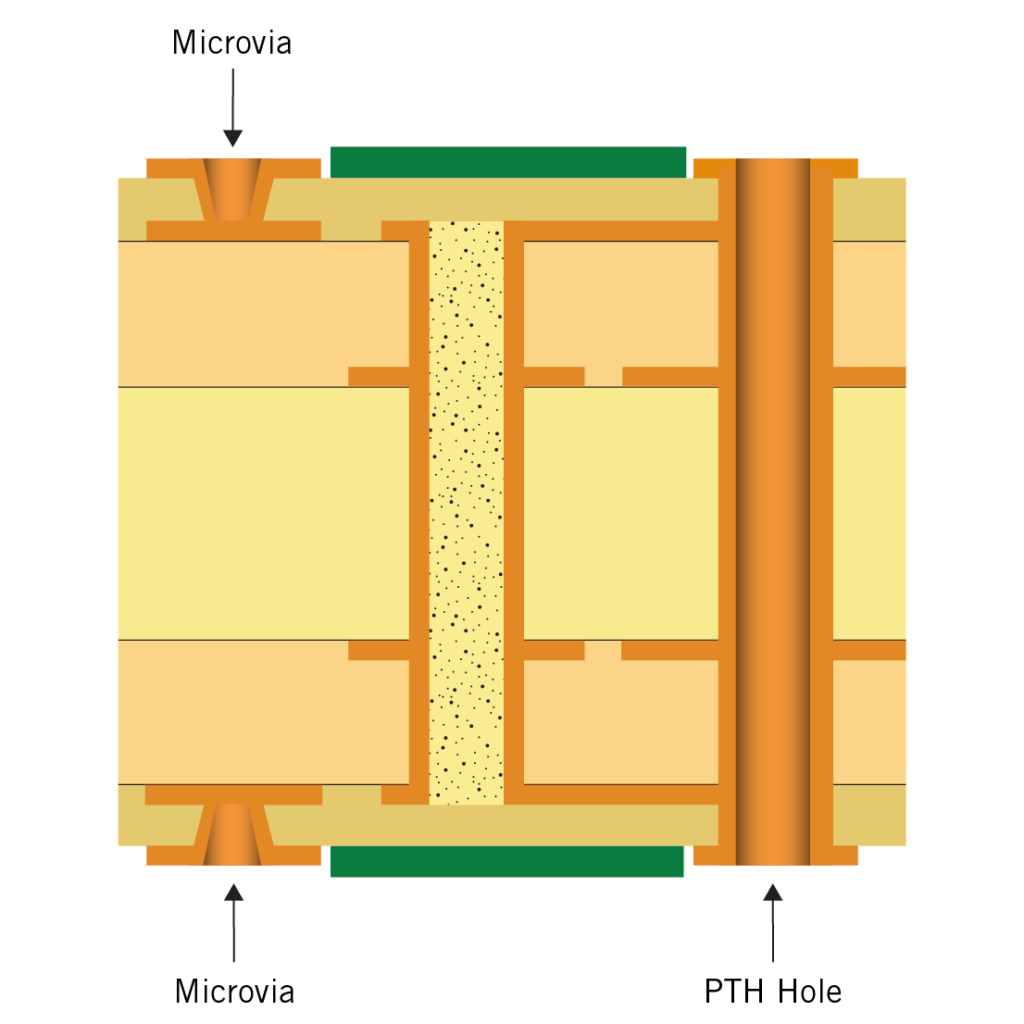
- LE STRUTTURE DI TIPO 2 sono simili al tipo 1 in quanto contengono solo un singolo strato di microvia su uno o entrambi i lati del nucleo. Utilizza per l’interconnessione sia microvia che fori passanti, ma a differenza del tipo 1 queste strutture impiegano anche i fori interrati.
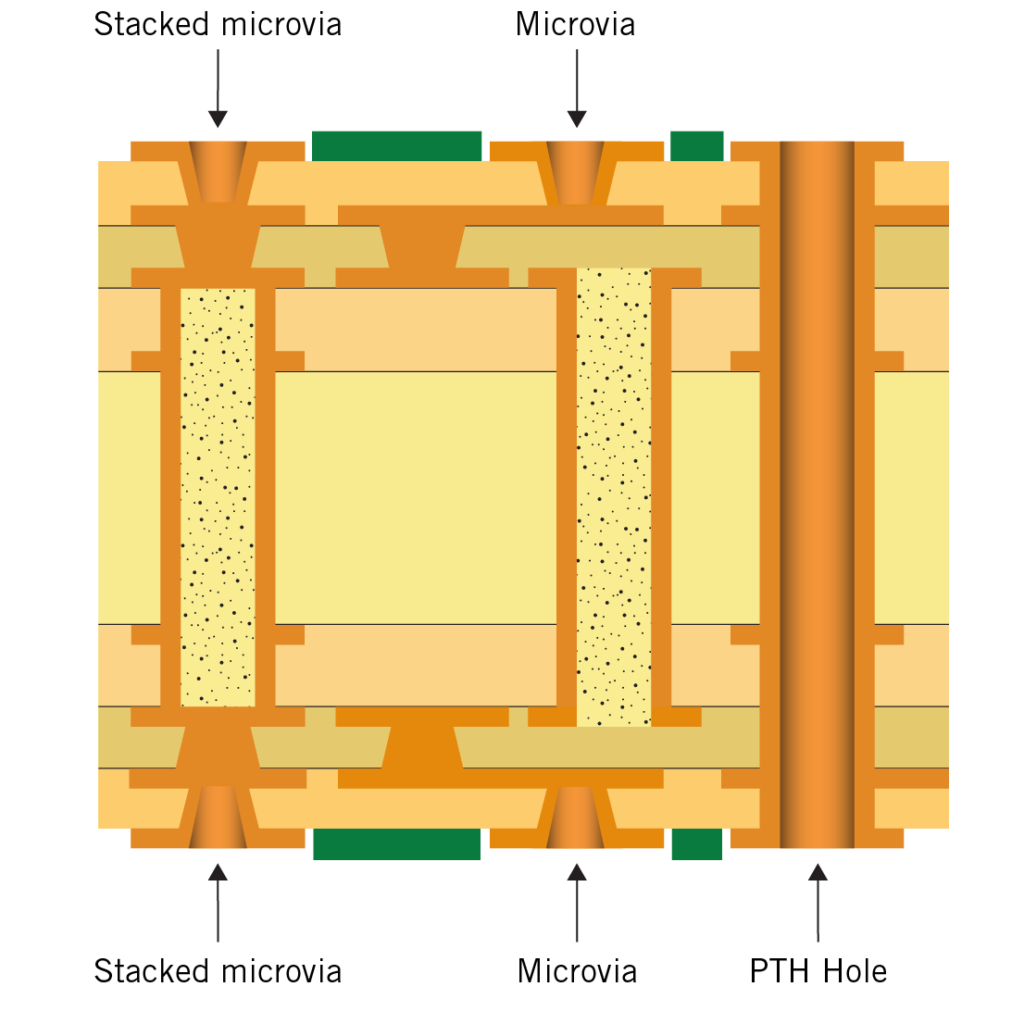
- LA STRUTTURA DI TIPO 3 sono ovviamente le piu complesse ed impegnative per le fabbriche, contengono ALMENO due strati di microvia su uno o entrambi i lati del nucleo. Come per il tipo 2, utilizza anche fori passanti oltre ai vias ciechi ed interrati
Il Perché di un HDI?
Sappiamo già cosa ci ha portato a questo, è la tecnologia che si sta evolvendo, estremizzando il tutto in termini di compattazione e miniaturizzazione. MA quali sono i vantaggi?
Estremizzando il tutto si possono ottenere design piu complessi in termini di spazio ed interconnessioni, utilizzare chiaramente Componenti di ultima generazione, incluso BGA passo 0,4 mm e inferiore, questi componenti hanno necessità di molteplici connessione in pochissimo spazio. Tornando a descrivere le tipologie di microvia, indispensabili per una costruzione HDI, possiamo trovarne esempi in una struttura Tipo III (Fig.1), sono strettamente legate a parametri ben definiti dalle regole di design, Regole disponibili sul nostro sito!
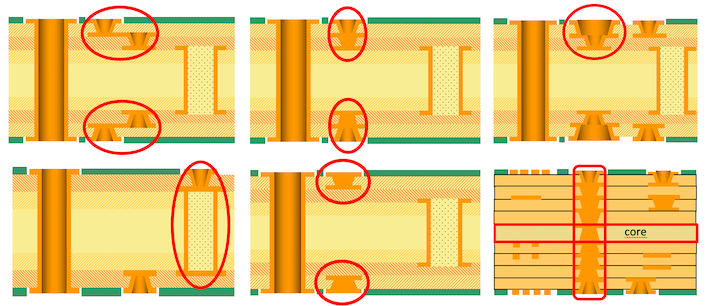
Microvias Staggered
Sono microvia sfalsati non sovrapposti, in questo caso il microvia interrato non ha necessita di essere riempito con il processo di copper vias filling.
Microvias Stacked
Sono microvia sovrapposti, in questo caso il microvia interrato ha necessità di essere riempito di rame, attraverso il processo di copper vias filling, processo ampiamente utilizzato per questa tecnologia.
Microvias Stepped
Sono microvia sovrapposti, questa costruzione abbastanza inusuale ha la caratteristica di avere due diversi diametri sovrapposti di fori ciechi. Per questa struttura non è necessario riempire di rame il primo livello dei fori ciechi.
Microvias on Pad
Per questa tipologia con i vias on pad, il foro interrato deve essere sempre fillato con resine epossidiche basso CTE, poi cappato con rame, in questo caso parliamo del processo vias filling, secondo IPC 4761 type VII.
Microvias filled on Pad
Per questa tipologia i vias on pad, sono fillati con il processo copper vias filling. Questo permette ai componenti di ultima generazione a passo molto fine di essere saldati sulle stesse pad forate.
Microvias ELIC
Questa tipologia i microvias sono sovrapposti, si parte da un core centrale attraverso un processo di foratura laser e copper vias filling in maniera sequenziale viene costruito l’oggetto. SBU (sequential build up).
Processo copper via filling
I vantaggi sono chiari per quanto riguarda dissipazione termica e maggior carico di corrente supportato. Ultimamente il connubio impianti e chimica hanno contribuito ad una migliore planarità delle pad Questo permetterà in fase di assemblaggio dei componenti una affidabile saldatura dei componenti di ultima generazione.
Per avere un buon Risultato Quello che vedete è sicuramente la giusta combinazione tra processo e design quindi:
- Avere Un buon foro laser, pulito e privo di fibre sporgenti.
- Un Controllo dei processi di desmearing e placcatura molto accurato
- Il diametro del foro laser compreso tra 80-100μm.
- Lo spessore dielettrico compreso tra 60-80 μm che oltre a permettere il giusto diametro del foro, come vediamo nelle foto, dar anche la possibilit di avere un dimple (depressione) di pochi um sulla pad forata.
Un breve accenno sugli step di questo processo Copper vias filling
La chimica contiene un particolare contenuto fra Brillantanti e Livellanti che consentono di riempire le cavità del foro cieco.
- Il brillantante agisce sul fondo accelerando il deposito del rame
- Il livellante impedisce il deposito in superficie e permette una planarità sufficiente per la saldatura sulle via on pad

Selezione dei Materiali
È importante selezionare i giusti materiali di base tenendo in considerazione le caratteristiche principali:
- Tg – Glass Transition Temperature
- CTE – thermal coefficient of Z axis expansion
- Td – Decomposition temperature
Tutti abbiamo sentito parlare del Tg di un materiale. Ma cosa è? Il valore di Tg, è la temperatura alla quale il materiale si trasforma da un materiale rigido come il vetro, a un materiale più elastico e flessibile come la plastica (Glass Transition Temperature). Questo valore è importante perché andare oltre il valore di Tg, le proprietà dei materiali cambiano e deteriorano.
CTE-Coefficiente di espansione termica, misura l’espansione del materiale di base, essenzialmente sull’asse Z quando viene riscaldato e di solito quando la temperatura è superiore al Tg, l’espansione è maggiore. Se il valore CTE dichiarato nel data sheet del materiale è troppo alto, possono verificarsi guasti durante l’assemblaggio poiché il materiale può espandersi più rapidamente oltre la Tg.
I materiali possono avere lo stesso valore di TG, ma con CTE diversi. In questo caso a parità di TG è preferibile scegliere un valore di CTE inferiore.
Temperatura di Decomposizione. Questa è una misura della degradazione del materiale. Il metodo analitico misura la temperatura alla quale il materiale perde il 5% della sua massa, a quel punto l’affidabilità è compromessa e possono verificarsi fenomeni di delaminazione. Un circuito stampato con maggiore affidabilità richiede un valore di Td ≥ 340 ℃
Per altre ulteriori informazioni su questa tecnologia rivolgetevi agli esperti di NCAB Group saranno ben lieti di dare supporto alle vostre esigenze.

Design guidelines for HDI
Download our PCB design guidelines for HDI to get your design right from start.
